
扫码添加微信,获取更多半导体相关资料
引言
集成电路制造过程中通常使用的清洗化学物质已经使用了很多年。尽管已知各种清洁化学物质对于当前一代集成电路设计规则是有效的,但是对这些化学物质的清洁机制和性能限制仍知之甚少。通过仔细的过程优化和对清洁机制的理解,这些化学物质通常可以被修改以保持或提高清洁效率,同时减少化学物质的使用。最常见的清洗化学物质包括用于去除重有机污染物、过渡金属污染物和颗粒污染物的氧化水溶液。硫酸和强氧化剂如过氧化氢的混合物通常用于去除高分子量有机物(如灰化光刻胶)。
近年来,大量的努力集中在优化SC-1和SC-2化学品的工艺性能上。已经表明,这些化学物质可以被充分稀释,同时仍然保持高清洁效率。本文将讨论SC-1清洁剂的优化,以最大限度地减少颗粒和有机污染、环境影响和拥有成本。只要施加足够的兆频超声波能量,稀释SC1清洗就能有效去除颗粒。这通过最大限度地减少化学品使用、漂洗水使用和废物处理,降低了拥有成本和环境影响。
实验
颗粒去除研究:实验面临的污染挑战是氮化硅颗粒,它是从气溶胶中沉积出来的,粒径范围从0.11 pm(计量检测下限)到0.30 Atm。用于这些实验的晶片是150毫米的Si<100 >,在稀释的(1∶10∶130)SC-1化学中预先清洗,以建立恒定的表面条件。在粒子沉积步骤和粒子去除清洁之前和之后进行粒子计量。首先进行筛选实验以确定颗粒去除的主要效果。然后评估经验响应面矩阵,以确定颗粒去除的最佳条件。
有机污染物去除研究:进行了设计性实验,以评估稀释的化学物质SC-1与应用的兆声波一起去除0.20微米以下的颗粒。然而,由于SC-1是一种氧化性化学物质,这种溶液可以去除低分子量有机污染物,并有助于去除颗粒物因为已经发现邻苯二甲酸二辛酯(DOP)等有机污染物会影响栅极电介质击穿。进行实验以确保稀释SC-1不会不利地影响轻质有机物的去除。
环境影响:使用稀释化学清洁剂的第一个附带好处是减少了化学物质的使用。可以很容易地进行计算,以确定通过稀释化学处理槽获得的化学节约量。废水处理中使用的化学品也可以通过减少需要由废物处理设施。然而,由于生产半导体晶圆厂的大部分化学污染物是酸性的,如果酸性和碱性废液一起处理,稀释的SC-1化学品(碱性)的废水处理节省可忽略不计。
稀释化学清洗的另一个主要环境效益是减少了用于清洗晶片的水。晶片通常被冲洗,直到冲洗水流出物达到预定的电阻率。达到所需电阻率所需的时间根据不同浓度的SC-1化学物质进行测量。简单的级联溢流冲洗用于完整的标准间距150毫米晶圆盒。这些实验的目标漂洗水电阻率为15 Mfl-cm。
总结和讨论
颗粒去除研究:只要施加足够的兆频超声波功率,即使当氢氧化铵和过氧化氢的浓度都显著降低时,SC-1化学催化剂在颗粒去除方面也表现良好。图1和图2显示了使用化学比率r = 1和r=0.01的氮化硅颗粒去除效率的等高线图,其中r定义为OH与H2O2的体积比。包括在图1的曲线图中的将是传统的浓度化学,1:1:5(ohihzo 2-H2O的比率);稀释至1:100:6900的化学成分包括在图2中。可以看到二次兆频超声波功率响应,以及对于两种浓度范围获得有效清洁的大区域。碱性SC-1中的静电效应很可能在实现有效的颗粒去除方面发挥重要作用,并且这些静电效应在稀释化学中可能会增强。稀释的化学物质具有降低的离子强度,随着离子强度的降低,双层厚度减小,因此排斥通过ζ电势相互作用增强。
这些结果表明,在高度稀释的氢氧化铵中,薄的化学或天然氧化物足以保护硅表面免受碱性侵蚀。由于当使用足够稀释的氨水时,清洁效率似乎对过氧化氢的存在不敏感,这些数据还表明表面蚀刻对于有效去除颗粒不是必需的。这些清洗不需要为了达到一定的蚀刻速率而定制,以便有效地去除颗粒。
有机污染物去除研究:在图5中看到由于HMDS的胺氮与亲水性表面(-OH端基)的羟基的反应。这是用于准备有机污染挑战的方法,这些数据作为对照组。所有其他晶片都经过了各种清洗,并给出了最终的残余污染水平(标准化为“硅+峰值”)。SC-1本身不足以去除HMDS,并且SC-1的稀释降低了去除HMDS的功效。然而,如图6所示,当稀释的SC-1与一套完整的闸门前化学清洗结合使用时(通常情况下),稀释SC-1清洗不会降低整体HMDS去除效率。最后,由于“Fab Clean”包括一种侵蚀性有机剥离清洁剂,因此进行了一项实验来评估当序列中省略了食人鱼清洁剂时,稀释的SC-1去除HMDS的功效。
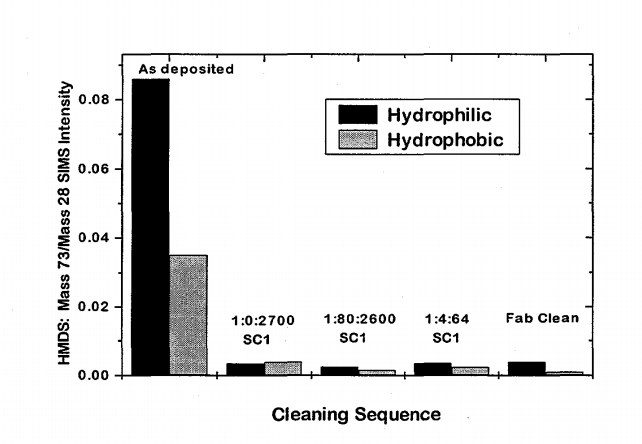
图6 HMDS移除与清洁顺序
环境影响:使用稀释化学物质SC-1可能的化学还原程度取决于许多因素,例如稀释程度、镀液寿命(通常至少8小时,取决于金属污染物的存在)和镀液体积。为了将几种不同的稀释度与传统的浓度SC-1进行对比,使用了每天倒入一个20升浴缸的基准。各种稀释度的预期化学用途如表1所示。此外,与传统的1:1:5清洗化学药品相比,化学药品的使用量减少了10%。显然,通过使用稀释浓度的SC-1可以大幅减少化学品的使用。稀释化学清洗的一个直接相关的好处是清洗后所需冲洗水的减少。
总结
清洗程序中使用的化学物质通常是根据历史先例选择的。因此,仔细检查化学成分和清洁顺序可能是合适的。例如,通过更好地理解SC-1化学品在去除颗粒和有机污染物方面的性能极限,可以显著减少化学品的使用..如果应用足够的兆频超声波能量,充分稀释的SC-l化学物质仍然可以高效去除颗粒。Zeta电位相互作用,而不是硅蚀刻,似乎是主要的颗粒去除的因素;浓缩到足以提供显著硅蚀刻速率的清洁化学物质不需要用于SC-1颗粒去除。使用稀释的SC-1去除轻质有机污染物的研究表明,如果SC-1作为独立的工艺使用,那么有机清洗效率可能会降低。然而,如果将SC-1与其他典型的栅极氧化前清洗步骤结合使用,则整个清洗顺序相当稳健,并且SC-1的稀释对有机去除没有明显影响。此外,为了去除轻有机物,可考虑在闸门前清洗程序中省略食人鱼步骤作为替代程序。省略这一工艺步骤将节省大量的化学和水资源。这些结果表明,使用优化的清洗顺序可以有效去除污染物,同时通常会减少化学品和水的使用。