
扫码添加微信,获取更多半导体相关资料
使用超临界流体去除污染物的过程,即高于其临界温度和压力的类气体物质。超临界流体具有类液体溶剂化特性和类气体扩散和粘度,使其能够快速穿透缝隙和边界层膜,并完全去除其中包含的有机和无机污染物。此外,通过在超临界和亚临界值之间循环压力,颗粒可以在脉动的膨胀阶段被非常有效地排出。超临界流体的定义可以通过查看相图来充分理解。
图2中的一氧化碳。关键特性是在任何压力下都不能出现超过临界温度(T)的冷凝。T右侧和P上方的区域定义了超临界状态。超临界流体的密度可以非常高。
二氧化碳作为清洗液:超临界CO被选为主要清洗液,因为其低粘度(0.05厘米泊)、高扩散率、非常低的表面张力,以及其他环境、安全和成本考虑。对于CO,临界温度T为31℃,临界压力也在实际范围内(Pc=73bar=1050psi)。
图3显示了略高于临界温度的等温线的密度与压力。密度随着临界点附近的压力而显著变化。例如,在31℃时,在环境压力下,密度仅为0.002g/cm3,而在PC下,密度为0.468g/cm3(增加了234倍)。
高于Pc的CO2具有与有机液体相当的密度和溶剂化能力。对于恒定的温度,CO2的溶剂浓度随压力而变化。物理化学性质可以在Pc以上和以下使用,即超临界和亚临界性质在设计良好的清洗过程中都很重要。在这一过程中,流体在两个压力之间循环,如图3所示。
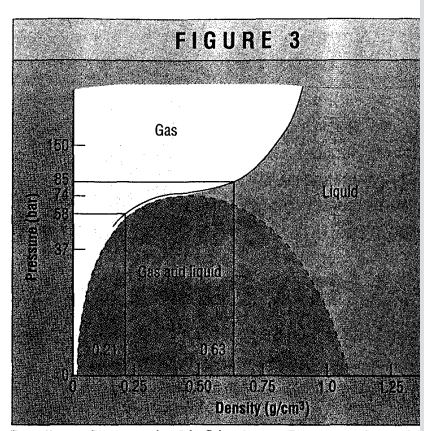
图3
晶圆清洗工艺:最近引入了一种使用CO2的晶圆清洗系统。如图4所示。晶片被装载在清洗室的上下方块之间。在加载期间,腔室高度约为5mm,晶片通过顶部块中的真空夹持保持在其中。然后较低的块被抬高,直到室被密封,此时腔室高度仅略大于晶圆厚度(1 mm)。在~800磅/平方英寸下加压的二氧化碳然后通过位于中心的孔供应。在清洗周期中,超临界流体由液压机构脉动。下腔块实际上是薄壁不锈钢膜,即隔膜。液压流体压力通过隔膜的弹性变形改变腔室高度,即超临界流体压力根据清洁腔室的体积而变化。压力通常以25至50赫兹的频率在800至1200磅/平方英寸之间循环。
不太频繁地使用单独的排出循环(每1到3秒)来用新鲜流体重新充满清洗流体。排出循环是通过降低下腔室块来实现的,因此在清洁腔室的外周向大气压力打开了一个2 pm的间隙。携带污染物的液体然后通过通道向外冲入排气系统。然后密封被重新关闭,新鲜流体通过入口阀进入,入口阀位于晶片室的上方和下方的中心。
超临界流体的“储存能量”是决定清洗效果的主要因素。残余物在膨胀过程中喷出,超临界流体在压缩过程中被迫进入缝隙。40秒的过程通常以这种方式去除所有污染物。然而,可以包括添加剂来改变流体的化学性质、极性或溶剂化能力。
微观清洗动力学:压缩循环混合并旋转上部和下部清洁间隙中的流体。密度增加三倍(从0.21到0.63克/立方厘米)。清洗液渗透到分子层和微米级的设备中。大量的流体运动有助于机械擦洗、颗粒移动和有机材料的溶解。在膨胀冲程期间,CO2从超临界流体变成亚临界气体。密度降低三倍,导致快速混合作用和流体从晶片表面流出。高速运动的流体迅速重新定位悬浮的颗粒和溶解的污染物。在排出步骤中,它们被补充清洗液冲出腔室。流感样病毒在整个过程中的快速流动阻止了病毒的再传播。
悬浮的污染物从清洗室中被重新移走,在每1到3秒钟的排出周期中。此时,几乎所有的流体都以横向向外的方向从中心排出。然后密封被关闭,向上的二氧化碳被集中注入上部和下部清洁间隙,使晶片变圆。
净化设备:双浮动(DF)、pulsa晶圆清洗装置如f所示,“DF”名称指的是t‹事实,即晶圆在临界流体中自由浮动,不接触晶片的顶部或底部。这是通过适当控制通过下部输入阀的流体流入来实现的,因此晶圆始终浮动在早期设计的缓冲垫上,只允许清洗晶圆的一侧。Th‹装置是一种先进的设计,可以同时清洗晶片的两面。下部清洁间隙非常小(< 30 pm)。结果,晶片跟随下腔块的往复运动。中部的液压驱动波轮驱动下腔块。这在上晶片清洁间隙和下晶片清洁间隙中提供了最佳的晶片清洁动作。在未加压(800磅/平方英寸)的位置,围绕晶片所有侧面的总流体体积只有大约S cm3 (= z N h - z 20 x 20 x 0.0125厘米)。这种低清洗液要求简化了对液体纯度的控制。
流体性质和腔室设计使得压力从晶片的顶面到底面变化很小。在任何给定的时间,甚至在冲程期间,腔室中存在基本均匀的压力分布。在清洗过程中,水被清洗液完全淹没。因此,晶片不会受到清洗液推力或压力变化的物理压力。隔膜是设备设计的关键要素。隔膜需要足够薄,以承受显著的弹性变形,同时足够坚固,以承受工艺要求的高操作压力。
化学处理,如高频蚀刻(湿法或无水法)不适合留下静电活化的晶片表面,该表面会吸引颗粒和化学污染物。这种氧化物去除或清洁过程之后通常是进一步的清洗和钝化晶片表面的处理。用超临界二氧化碳清洗可以缓解静电问题,因为晶片和清洗室金属壁之间的流体体积已经最小化。此外,高压清洁剂可以包括添加剂以钝化表面。