
扫码添加微信,获取更多半导体相关资料
最近的电子器件大多是由微细的电路元件构成的,为了制造这些元件,微细加工已成为必须的技术。以前,为了这个目的使用了蚀刻技术(光刻法)。但是,半导体集成电路(IC)的集成度以年率约2倍的比例提高,据说使用光的加工早晚会达到极限。为了打破这一问题,正在研究使用更短波长的紫外线、电子射线、软X射线、离子射线等新射线源的方法。另一方面,适用于这些新辐射源的抗蚀剂材料的研究也在势力范围内进行。在此,以光刻胶为中心,对各光刻胶的现状、今后的课题进行概述。
光刻法
图1 示出了使用光刻的微加工的概略工序。首先在基板表面形成要蚀刻的物质(例如铝)的薄膜,在其上通过旋涂法等涂覆抗蚀剂。光刻胶是通过光照射,其溶解性发生变化的被膜材料,在蚀刻时具有保护基板的作用。通过具有所需图案的光掩膜(类似于照相干板),用光照射涂有光刻胶的基板,使其发生化学变化后,将其浸入适当的溶剂(显影液)中,仅照射部分或未照射部分有选择性地溶出,形成光刻胶的图案,因此,溶解性增大,该部分溶出的称为正型抗蚀剂,相反,通过照射使其不溶解,仅未照射部分溶出的称为负型抗蚀剂。 接着,使用适当的蚀刻剂对该基板进行蚀刻后,被抗蚀剂图案覆盖的部分未被蚀刻而残留。 最后,剥离作用结束的光刻胶后,可以得到所需的蚀刻图案。
当然,光刻光源必须产生波长足以使光刻胶光解或光交联的光。实际上使用的是水银灯,在其发射光谱中,主要使用g线(435 nm)、h线(405nm)、i线(365nm)。 但是,缩小投影曝光方式使用单色光是标准的。使用该光源对涂有光刻胶的基板进行曝光时,使用了以下4种方法: ①接触曝光法②代理米特曝光法③等倍反射投影曝光法④缩小投影曝光法。在接触曝光法中,顾名思义就是将基板与掩膜紧密接触后进行曝光。这种方法从很久以前就开始使用,虽然可以得到较高的分辨率,但是由于掩膜与基板接触,其缺点是抗蚀剂膜容易被划伤,掩膜容易被弄脏。
代理曝光是为了消除上述缺点,将基板和掩模分开数十微米进行曝光的方法。这样,虽然可以减轻上述缺点,但却无法避免分辨率的降低。现在大部分的曝光装置(掩模对准器)都可以通过简单的操作进行选择,一般是根据目的分别使用。在等倍反射投影曝光法中,使用由反射镜构成的光学系统,将掩膜的图案在没有色差的情况下,以1:1的比例投影到基板上进行曝光。在这种情况下,掩模与基板充分分离,完全不用担心抗蚀剂膜的损伤和掩模的污染。在缩小投影曝光法中,使用具有实际芯片n倍(n一般为5、10)图案的掩模(分划板),使用透镜投影缩小像进行曝光。
深度UV光刻
在光刻中,最小分辨率线宽在接近式曝光中与波长的1/2次方成比例,在投影曝光中与1次方成比例,因此短波长化当然能够有效提高分辨率,但该方法的另一个特长是不使用增感剂就能够分解乃至交联许多有机聚合物 可以认为,PMMA的高分辨率对上述分辨率、0.2μm、有很大的贡献。以上的丙烯酸类光刻胶都具有高分辨率,但它们的通病是灵敏度低以及耐干蚀刻性不充分。
在通常的微细加工中,通过在抗蚀剂图案形成后蚀刻曝光部分来形成所需的图案(图1)。 与此相对,作为另一种图案形成法,剥离法广为人知。在该方法中,如图4所示,在基板上形成光刻胶图案后,在其上用真空蒸镀法等形成皮膜,然后用良溶剂进行光刻胶溶解除去。

图4 使用LMR阻力的提升过程
此时,沉积在光刻胶上的膜也与光刻胶一起被一一除去,只残留沉积在谷间的膜,形成图案。 该方法对于难以蚀刻的金属、化合物的图案形成特别有效。 如图4所示,为了确实进行剥离,光刻胶的断面为倒梯形(或蘑菇状)是必要条件。因此,虽然提出了多层抗蚀剂法、氯苯处理法)等方法,但工艺复杂、再现性不充分等,不能满足。
我们通过简单的显影工序,开发出了具有蘑菇状断面的图案再现性良好,灵敏度高(PMMA的100倍以上)且分辨率为0.3μm(接触法)的专用Deep UV负型光刻胶“LMR”。 LMR的主要成分是萘醌二甲酸酯的磺酸酯(IX),是分子量为1000左右的低聚物。 利用该抗蚀剂形成铝图案的例子如图4所示。
电子束(EB)光刻
如图5所示,由于入射EB在向前散射的同时通过抗蚀剂层,因此在这里产生了一定程度的强度分布。电子进一步进入基板,到达一定深度后,被反向散射。关于反向散射的硅基团关于板上的PMMA抗蚀剂膜的体系,报告了利用蒙特卡罗法的模拟结果,其扩散远远大于前方散射的扩散。例如,在涂有厚度为1μm的PMMA光刻胶的硅基板上照射20keV的EB时,光刻胶/基板界面上的背散射引起的电子扩散达到2μm左右。从该结果可以很容易地想象,反向散射是导致分辨率降低的重要原因。例如,用20keV的EB描绘2μm间隔的图形时,如图5所示,在目标图形的描绘中,相邻的图形也会在一定程度上被曝光。这就是所谓的邻近效应,是EB光刻分辨率降低以及描绘尺寸变动的主要原因之一 特别是在通过EB照射进行交联的负型光刻胶的情况下,影响较大。为了打破这一局面,有人提出了一种以更高的高压(~50kV)加速,通过加深电子进入来降低邻近效应的方法。
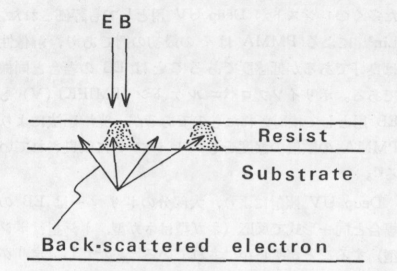
图5 EB光刻技术中的后向散射和接近效应
EB抗蚀剂
有机聚合物对于电离放射线可以分为分解型和交联型,与光刻胶的情况相同,分解型可以是正型光刻胶,交联型可以是负型光刻胶。 在EB光刻中,由于使用的是能量比分子的结合能量大得多的EB,因此可以成为光刻胶(通过EB照射发生化学变化)的物质很多。但是,实际上具备抗蚀剂条件的极少。在EB光刻胶的情况下,与光刻胶一样,下述性质基本是重要的。
X射线光刻
由于X射线的波长较短(0.5~5nm),衍射的影响较小,且与EB相比,透射能力相差悬殊,因此,以X射线为辐射源的光刻有望获得高分辨率。 研究了使用软X射线的光刻,证实了在大长宽比下可以转录细微的图案。之后,对线、源、掩模、曝光装置等进行了势力性的研究。将X射线应用于光刻时,目前仅限于使用掩膜的转录。
聚焦离子束光刻
在EB光刻中成为大问题的反向散射可以通过使用离子束作为辐射源来减轻。此外,通过离子照射产生的二次电子的平均能量低于EB照射的情况,并且由于可以消除邻近效应,因此提高了分辨率。另外,由于抗蚀剂对离子束的阻止能力大,表观灵敏度提高。该方法的另一个特点是可以进行直接蚀刻、离子注入、离子束辅助蚀刻等。以离子源为首,还需要大量的研究和开发,但将来有可能实现完全不使用抗蚀剂的器件制造技术,这是一项梦想很多的技术。
总结
以上,以抗蚀剂材料为中心,叙述了光刻技术的概要。该技术是电子工业中的中枢技术,其要求越来越高。光刻是高度的复合技术,只要缺少一个构成要素,就无法发挥作用。例如,无论曝光装置如何进步,如果没有与之相适应的光刻胶,就不可能实现实用化。因此,今后共同使曝光系统、光刻胶及工艺技术以协调的形式进步是极其重要的。
最近,将光刻工艺干化的研究取得了进展。关于这一点,本文有很好的解说,在此不作叙述。光刻胶仅限于有机物。