
扫码添加微信,获取更多半导体相关资料
引言
在作为半导体光刻原版的光掩模中,近年来,与半导体晶圆一样,图案的微细化正在发展。 在半导体光刻中,通常使用1/4~1/5的缩小投影曝光,因此光掩模上的图案线宽是晶圆上线宽的4~5倍,虽然要求分辨率比半导体工艺宽松,但近年来,从边缘粗糙度、轮廓形状等角度来看,干蚀刻已成为主流。 半导体用光掩模是对在合成石英基板上成膜的铬、氧化铬、氮化铬等铬系薄膜进行图案化的掩模,特别是在尖端光刻用掩模中,现状是从硝酸铈系的湿蚀刻剂加工,基本完成了向氯、氧系混合气体的等离子蚀刻加工的转移。
在提高光刻分辨率的相移掩模技术中,湿法蚀刻技术再次受到关注。 这是因为,在蚀刻玻璃基板,使曝光光具有相位差的Levenson型相移技术中,通过湿法蚀刻控制图案轮廓的形状是不可或缺的。在本文中,简单说明了需要这种技术的背景,并介绍了使用湿法蚀刻的尖端光掩模制造的现状。
关于光刻技术和掩模
半导体光刻技术取其最小线宽或设计中的最小间距的半数,多在世代或技术节点中进行讨论。迄今为止,为了实现更精细的技术节点,主要通过光刻的短波长化进行了应对,但近年来,图案的精细化正在以超过短波长化的速度发展。
一般来说,对于曝光波长形成的线宽足够大,转印对比度充分的光刻,MEEF为1。也就是说,掩模的尺寸误差只在缩小倍率部分小,反映在晶圆上的状态。 另一方面,当形成的线宽小于曝光波长时,MEEF变大,有时达到2-3以上。也就是说,转印对比度变小,掩模的微小尺寸误差被放大,成为晶片尺寸的误差。因此,尖端光刻对掩模尺寸精度的要求加速增加,成为使掩模制造变得困难、成本上升的一个主要原因。图3显示的是,对于铬掩膜和半色调型·Levenson型的各PSM,对波长:193nm的65nm技术节点的MEEF进行模拟的结果。由此可知,在铬掩模和半色调型相移掩模中,可以看出MEEF很大,控制转印尺寸非常困难。与此相比,对于Levenson型相移掩模,尽管在相同的曝光波长下形成相同的微小线宽图案,但MEEF被抑制得很小。由此可以认为,对于目前正在开发的65nm技术节点,Levenson型相移掩模将成为必备技术。
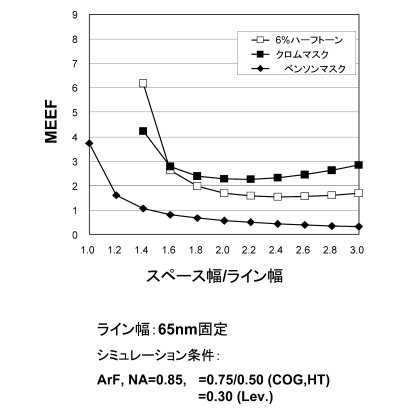
图3 65纳米线MEEF模拟
制造底切结构的方法
之前说明的现在主流的底切结构是将各向异性高的干法刻蚀技术和各向同性的湿法刻蚀技术相结合制造出来的。 图8显示的是底切结构的Levenson型相移掩模的制造流程。 下面简单说明一下制造流程。首先完成普通的铬掩模后,在基板上再次涂上抗蚀剂,一边与铬图案对准,一边进行第2层的抗蚀剂图案化,以露出玻璃蚀刻部分。接着,将该光刻胶图案作为掩模,首先利用氟类(CF和SF气体等)气体进行干蚀刻。这里主要使用平行平板型的RIE装置,或者ICP等高密度等离子体装置。然后,通过喷射氢氟酸作为湿蚀刻剂或将其浸入浴缸中来进行各向同性湿蚀刻,从而形成底切。
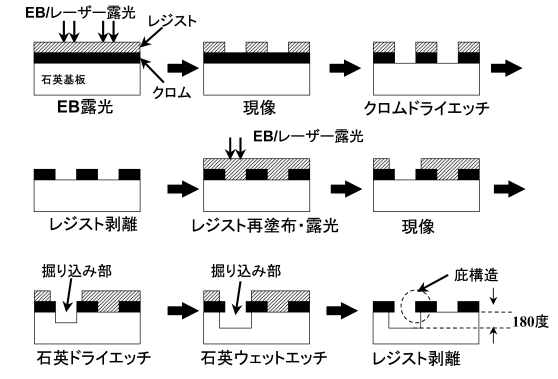
图8 Levenson型相移掩模的制造方法
另外,对于相移掩模,相位差必须为180度,如果曝光波长确定,则通过玻璃基板的折射率统一确定挖入深度。 另一方面,底切量在相同曝光波长下,根据图案种类(线系统、孔系统等)和光刻条件,最佳值经常发生变化,另外,如上所述,根据开口部尺寸的尺寸偏差的有无也会发生变化。因此,为了实现适当的底切量,改变了干法蚀刻和湿法蚀刻的比率。 表2显示了其中的一个例子。 到目前为止,在量产阶段使用的Levenson相移掩模的情况下,干蚀刻深度与湿蚀刻深度的比,只要准备几种变化就足够了。
对于挖入玻璃类型的Levenson型相移掩模,蚀刻没有终点是其最大的特征。 如前所述,蚀刻深度给出相位差,但相位差要求控制在1度水平(半导体相关国际路线图要求65nm技术节点的相位差精度为180度±1度),要求精度在1%以下。 在没有终点的蚀刻的情况下,对于相位差的分布,蚀刻速度的分布会原封不动地发挥作用,但一般情况下,能够以1%的精度进行蚀刻的技术并不简单。
另外,在光掩模的情况下,连续制造好几片同一图案的情况很少,通常每一片图案的覆盖率(被蚀刻的面积率)不同。特别是在蚀刻工艺中,如果覆盖率发生变化,蚀刻速度就会发生变化,要达到上述的1%就越来越难了。 在比较合成石英的蚀刻技术时,目前的现状是,相对于这些相位差精度的要求,湿法蚀刻更占优势。
此外,目前,为了满足相位差规格,在Levenson型相移掩模的蚀刻方面,出现了不是一下子进行规定的蚀刻,而是中途从蚀刻装置中取出一次,测量当时的蚀刻深度后,以计算出的蚀刻速率进行追加蚀刻的情况。另外,采用了在180度前暂时停止蚀刻,一点一点地反复追加至所需深度的方法。 在这种情况下,从追加蚀刻的稳定性等方面来看,湿法蚀刻是有利的,能够实现更高精度的相位差控制(中心值控制)。
总结
本文介绍了半导体光掩模中,湿蚀刻技术不可或缺的Levenson型相移掩模的现状。 结合湿法蚀刻的各向同性和干法蚀刻的各向异性,对于此前在平面上发挥功能的光掩模,导入立体结构,实现了能够延长光刻寿命的掩模。目前,这种结构的Levenson型相移掩模已经在量产水平上用于部分用户的特定器件,对于65nm技术节点,其适用范围将会扩大。