
扫码添加微信,获取更多半导体相关资料
引言
III―V族的化合物半导体GaAs,与Si半导体相比,如果能利用快6倍的电子移动度和少的配线容量,就有利于高速化,由于是单纯的晶体管的构造,高集成化元件也是合适的。根据这样的特征,GaAs在超高速演算元件,半导体激光,通信领域被广泛应用。以Si晶圆为代表,用于器件平坦化的CMP被积极地研究。但是,GaAs晶圆的CMP与其重要性相比,研究并不多。这是因为GaAs晶圆的直径还很小,使用量也不如Si,即使是现有的浆料也能满足CMP特性的要求。
目前,III-V族化合物半导体,特别是GaAs和lnP晶圆的CMP用浆料主要使用次氯酸钠(NaOCl)作为蚀刻剂,其镜面加工的机理也在考察中。但是,由于对环境问题的应对越来越多,对开发新的GaAs超精密抛光用浆料的要求越来越高。本方法的主要目的是开发对人体和机器的工作环境无害的新的GaAs CMP浆料。
实验
本方法中的GaAs晶圆是Si掺杂N―type的(100)方位角。浆料的成分是具有光触媒用锐钛矿结晶状的TiO2的粉末,过氧化氢使用30%浓度的溶液。为了比较加工特性,使用了GaAs晶圆专用的研磨药品。研磨实验全部进行了3次。
图1表示实验装置。图1(a)是一般的CMP装置的模式图,(b)是为了调查本研究中使用的紫外线照射的影响的CMP装置。在表面板上使用紫外线吸收少的石英,为了将紫外线通过石英直接照射到晶圆面上,在垫上开孔进行CMP.GaAs晶圆切成10×10mm2,如图1(b)所示均等地贴上。其他的研磨条件如表3所示。紫外线照射用波长为365nm的水银―氙灯进行,使用紫外线照射的平均强度为3500mW/cm2的LA―300UV。
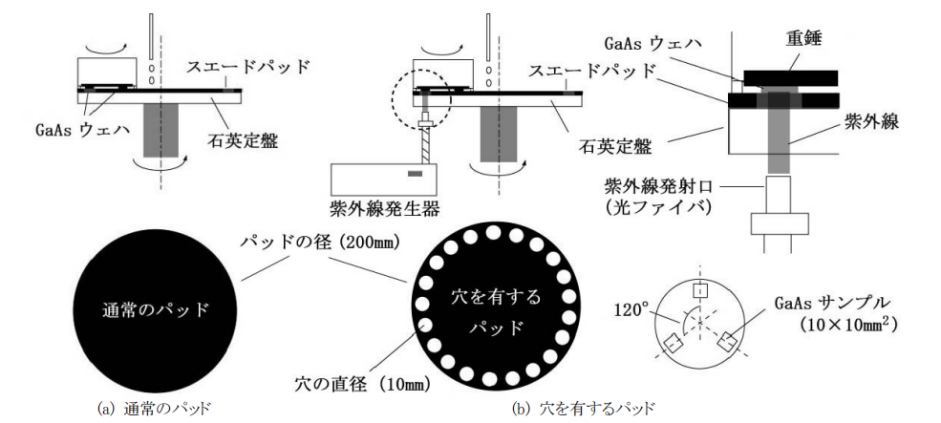
图1 实验装置的示意图
首先,我们仅使用通常在半导体领域用作氧化剂的过氧化氢对GaAs晶圆进行了抛光。过氧化氢的浓度使用了30%的溶液。研磨前、研磨30分钟后以及研磨60分钟后的表面形状如图2所示。从图2的形状结果可以看出,平坦化没有进展,仅用过氧化氢的研磨几乎没有进行。这样的结果,用TiO2―H2O的浆料的研磨也是一样的。
结果和讨论
最初,使用TiO2―H2O2的浆料,进行了60分钟的研磨。使过氧化氢的浓度从3%变化到30%。图3显示了研磨前的酸的蚀刻面和根据浓度变化被研磨的晶圆表面的图像。研磨前的深蚀刻痕随着研磨时间和浓度的增加而减少,平坦化正在进行。特别是在15%以上的浓度的研磨表面上,蚀刻痕完全消失,被镜面化。
对高浓度的过氧化氢浆料抛光的影响进行了考察。特别是使用30%的过氧化氢浓度时,在20分钟左右由于产生了大量的反应气体,显示了沸腾状态的样子,容器的温度也变得相当高。因此,测定了研磨中供给的浆料的混合时间的温度变化。图4是测定的温度变化的曲线。浓度越高,温度上升的梯度越大,过氧化氢的浓度为30%时,20分钟后上升到约97℃。
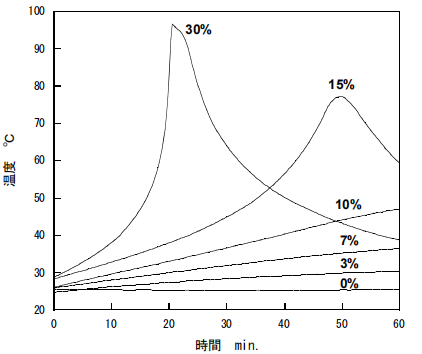
图4 TiO2-H2O2随时间的温度变化
图6是用15%的过氧化氢和TiO2粉末的泥浆进行1小时的研磨,使用AFM和WYKO进行其表面的评价的结果。图6(a)的表面的观察领域为1μm×1μm,Z轴的长度为2nm.AFM的Ra大约为0.1 nm,P―V为1.4 nm.图6(b)显示了更大范围(368μm×240μm)下的结果。在该WYKO的表面形状测定中,Ra为0.54 nm.另外,1小时的平均研磨率为0.29μm/min.该结果与GaAs晶圆专用的研磨剂的研磨特性进行了比较。
首先,通过XPS分析,阐明了紫外线对过氧化氢的光分解效果对GaAs表面的影响。将GaAs晶圆浸入浓度分别为3~5%的过氧化氢中,用紫外线照射5分钟。另一个样品在没有紫外线照射的情况下放置5分钟。测量了各晶圆表面的Ga3d轨道和As3d轨道的峰值变化,其分析结果如图8所示。在没有紫外线照射的图8(a)和(b)的情况下,过氧化氢对晶圆表面的氧化正在进行。表面上GaAs,Ga2O3,As2O3以及As2O5峰共存。在Ga3d的轨道的情况下,GaAs以及Ga2O3的峰显示出大致相同的高度。

图8 XPS对是否只使用过氧化氢进行紫外线照射的表面分析
基于这样的XPS的结果,对各个浓度的研磨效率进行了实验验证。图9显示了研磨时间的研磨量的变化以及误差。整体上有紫外线照射的图9(b)比(a)研磨量稍高,相对于时间的梯度也变大。特别是浓度为3%的情况下,与10%和15%的浓度相比,研磨量的差更明显。可以推测这是因为浓度越高,与紫外线的影响相比,浆料的分解反应产生的热的影响越强。另外,根据本方法的结果,虽然可以看到紫外线照射的效果若干,但效率与温度上升产生的效果相比较低。
总结
在本方法中,使用新的泥浆系统H2O―TiO2―H2O的泥浆,对GaAs晶圆表面的研磨的可能性进行了考察。(1)测量浆料相对于过氧化氢浓度的温度变化,调查了研磨效率的差。根据温度变化,研磨效率有很大的差。特别是过氧化氢浓度为15%的情况下,AFM的Ra大约为0.1 nm.与以往的浆料相比,虽然研磨速率有所下降,但可以得到更好的平滑性。(2)研究了光分解(photolysis)和光催化作用(photocatalysis)在研磨中的应用。XPS的分析结果虽然可以看到紫外线照射的表面氧化状态的差别,但是在实际的研磨中应用的结果,可以看到研磨量的差别很小,而且研磨表面的平滑性没有差别。这是因为光分解产生的羟基自由基是强力的氧化剂,但是对GaAs晶圆表面的氧化是否有效果还不明确。