
扫码添加微信,获取更多半导体相关资料
引言
我们研究了高温退火法对4h-SiC蚀刻形状的转变。虽然蚀刻掩模是圆形的,但蚀刻的形状是六边形、十二边形或十八边形,这取决于蚀刻面积的大小(图。 1).六边形经过高温退火后,六边形转化为十二边形,十二角形转化为十八边形。 1).不同边缘方向的六边形和十边形的十二边形在退火过程中经历了不同的转变。 2).一条对应于一个{1-10x}面的边显示为一条直线,似乎是最可取的。与{11-2x}面对应的边缘也出现在一个曲线特征中,这表明它是第二大首选。明显的结构(密集),但在11-2倍的表面上微弱(微弱)。 3).因此,在考虑退火变换的情况下,需要在实际器件中设计形状及其方向。
我们报告了在SiC沟槽型MOSFET的制作中,通过SiH4/Ar和H2气氛中的2阶段高温退火,可以改善沟槽形状控制和蚀刻侧壁的平滑性(6)。 研究过程中发现SiC表面形状的变化具有晶面取向各向异性。 此次,我们调查了高温退火引起的变形因蚀刻面积和形状的不同而不同,以及退火形成的晶面方位的稳定性。
实验方法
对4H―SiC基板(n型,8°关断,C面)进行清洗后,使用等离子CVD装置成膜了厚度为2.5μm的SiO2膜。 使用一般的照相工艺,在直径不同的圆形、6角形、12角形上对光刻胶进行了图案化。 然后用抗蚀剂作为掩模,用干法蚀刻法蚀刻SiO2图案化了。 干蚀刻是用CHF3/Ar气体在3Pa的压力下使用RIE装置进行的。 剥离光刻胶后,以SiO2图案为掩模,使用ICP蚀刻装置对SiC进行干法蚀刻。 蚀刻条件为ICP功率450W,偏压8W,用SF6/O2/Ar气体在2Pa的压力下进行。 蚀刻深度约为4μm。 剥离氢氟酸残留的SiO2膜后,在80Torr的压力下,在添加SiH4―0.09%的Ar气氛中,在1700℃下进行10分钟至120分钟的退火。 利用扫描电子显微镜(SEM)评价了蚀刻后和退火后的形状。
实验结果讨论
将图案化成面积不同的圆形(光掩模为72角形)的试料进行干蚀刻时的蚀刻形状的SEM观察结果如图1所示。 圆的直径约为1.7μm时,蚀刻形状为具有与{1―10x}面对应边的6角形(Hexagon)。 直径约为5.6μm时为12角形(Dodecagon),直径约为12.5μm时为18角形(Octadecagon)。 随着蚀刻面积的增加,被蚀刻成更多的多角形,根据蚀刻面积的不同,形状也不同。 需要考虑的是,即使是相同的图案形状,干蚀刻形状也会因面积而异。
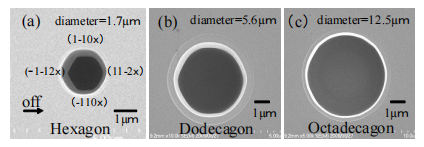
图1
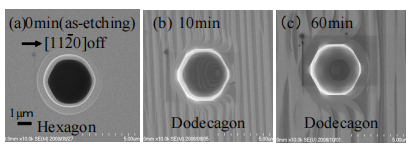
图2
图2显示的是蚀刻成直径约4μm的圆形的试料蚀刻后的形状,以及在添加SiH4―0.09%的Ar气氛中,在80Torr、1700℃下退火10分钟和60分钟后的SEM观察结果。 在没有退火(as―etching)的状态下,形状接近于6角形,但如果进行退火10分钟以上,就会变形为12角形。
图3显示的是以约8μm的尺寸蚀刻成6角形的试料在蚀刻后的形状和SiH4/Ar气氛中在80Torr下在1700℃下退火120分钟后的SEM观察结果。 图3(a)是具有与{1―10x}面对应的边的六角形蚀刻后的SEM照片,(b)是将(a)的六角形旋转30度后具有与{11―2x}面对应的边的六角形蚀刻后的照片,(c)是(a)退火后的照片,(d)是(b)退火后的照片。 当蚀刻成具有与{1―10x}面相对应的边的6角形时,退火后角也会变圆,但30度旋转蚀刻成具有与{11-2x}面对应边的6角形时,退火后变形为12角形。 12角形不是正12角形,与{1―10x}面对应的边是直线,与此相对,与{11―2x}面对应的边是弯曲的。 图4显示的是以约8μm的尺寸蚀刻成12角形的试料在蚀刻后的形状和SiH4/Ar气氛中在80Torr下在1700℃下退火120分钟后的SEM观察结果。 图4(a)是具有与{1―10x}面及{11―2x}面相对应的边的12角形蚀刻后的SEM照片,(b)是将(a)的12角形旋转15度,顶点存在于<1―100>及<11―20>方向的12角形蚀刻后的照片,(c)是(a)退火后的照片,(d)是(b)退火后的照片。 将其蚀刻成具有对应于{1-10x}面和{11-2x}面的边的十二边形。
实验中,将蚀刻成约9μm大小的圆形的试料在SiH4/Ar气氛中,在80Torr下,在1700℃下退火120分钟后的SEM观察结果。并记载了从圆形变形为12角形后的面指数。 观察12角形的各边,可知与属于{1―10x}的各面相对应的边为直线,而与属于{11―2x}的各面相对应的边稍有弯曲。 这些结果可以预测,在12角形中,也有因变形而容易出现的稳定面和难以出现的面。
如果进行非常长时间的退火,估计最终会变成6角形。 通过退火变形为12角形时,明确出现属于{11―2x}的面,可以认为是由于表面张力的周长最小化的力起作用,在变形过程中这些面在表面能上稳定。 在Si中,也有在H2退火的变形过程中观察到小面的报道,在SiC中,在12角形中,属于{1―10x}的面变得稳定,认为可以观测到小面在本论文中,对4H―SiC上形成的干蚀刻形状的高温退火引起的变形进行了论述。
干蚀刻当蚀刻面积较小时,蚀刻形状为6角形。 通过面积的增加和之后的退火,变形为12角形和18角形的多边形。 6角形和12角形根据形成方向有无变形,属于{1―10x}的面比属于{11―2x}的面形成稳定。 这样,在使用4H―SiC基板制作器件时,由于退火后稳定出现的晶面会因蚀刻的形状、方向而发生变化,因此需要考虑变形的设计。 例如,在4H-SiC的C面基板上形成沟槽MOSFET时,如果在沟槽侧壁上以(1―100)和(―1100)面出现的方向进行蚀刻,退火后也能形成稳定的侧壁面,但如果方向相差90°,侧壁面就会弯曲,推测难以形成直线。 另外,作为周边耐压结构,即使在通过蚀刻形成台面时,也需要考虑角部的形状。