
扫码添加微信,获取更多半导体相关资料
本文公开了一种用湿式均匀清洗半导体晶片的方法,所公开的本发明的特点是:具备半导体晶片和含有预定清洁液的清洁组、对齐上述半导体晶片的平坦区域,使其不与上述清洁组的入口相对、将上述对齐的半导体晶片浸入清洁组的步骤、旋转上述沉积的半导体晶片的凸缘区域,在规定的时间内清洗上述旋转的半导体晶片、将上述清洁的半导体晶片浸入上述清洁组之外的步骤。
涉及半导体晶片湿式清洗方法,特别是,半导体晶片用湿式均匀清洗方法。一般来说,半导体器件制造过程中,通过氧化和扩散过程、照相过程、蚀刻过程和薄膜沉积过程等,将半导体器件聚集到Weiper中的过程中,会伴随着粒子、灰尘和水分等不可选择的杂质。这种杂质是引起半导体器件物理缺陷及特性下降的原因,最终会使器件的收率下降。因此,为了使元件的收率保持在适当状态,正在单位工序前后进行清除不需要的杂质的清洗过程。

图1
图1是用于说明根据现有技术的半导体晶片清洗方法的图纸。参照图1,为了从晶片(10)的表面消除污染源,将晶片(10)的平坦区域对准预定方向,然后将晶片(10)浸泡在含有清洗液的清洗槽中,这时,晶片的平坦区域按照不与洗涤池的入口相对的方向排列。因此,晶片按A区域、B区域、C区域的顺序沉积在洗涤池中。在这里,清洗液由适当的溶剂或化学溶液组成,以消除目标污染源。在图1中,箭头指示晶片(10)沉积在洗涤液(20)上的方向。
其次,在规定的时间内保持晶片(10)的沉积状态,以便彻底消除晶片(10)表面的目标污染源。此时,为了有效地去除有机膜、离子性粒子和大约3000毫米左右的小粒子,还会使用超或甲加丹上的超声波。接下来,通过将晶片(10)浸泡清洗槽(20)转子后进行自旋干化(Spin Dry),将留在晶片表面的清洗液干燥,完成清洗过程。
这样,在传统的半导体晶片清洗方法中,以晶片的平坦区域为标准,仅在一定方向上沉积在清洗液中,清洗晶片。在这种情况下,不需要的杂质会溶解,从而产生流动性粒子缺陷。
图2a和图2b是根据现有技术显示流动性粒子缺陷的图纸。如图2a和图b所示,在传统的清洗方法中,只有半导体晶片的特定区域(C)中才会出现清洗液的溶解速度差引起的杂质残留。更详细地说,与A区域相比,B和C区域在更短的时间内接触清洁液,因此A区域充分清洁,而B和C区域通过相对较短的清洁时间,将出现流动性口型自缺陷现象。
这种流动性粒子缺陷现象将成为直接影响器件电气特性劣化的主要因素,半导体器件电路模式的精细化将取得进展,随着其精度的增加,其对器件的影响力将进一步扩大。因此,本发明的目的在于为了解决上述问题,通过在晶片浸泡在清洗组中的情况下向预定方向旋转,缓解晶片各区域的溶解速度差,提供防止流动性颗粒缺陷现象的半导体晶片湿式清洗方法。
为了达到上述目的,根据本发明的半导体晶片清洗方法是,具备半导体晶片和含有预定清洗液的三个贞操的步骤;对齐上述半导体晶片的平坦区域,使其不与上述洗涤器的入口相对;将相位对齐的半导体晶片浸入洗涤池的步骤;上述沉积半导体晶片的襟翼旋转,使其不与洗涤器的入口相对;上述旋转半导体晶片在规定时间内清洗的步骤;以及具备将上述清洗的半导体晶片浸入上述清洗槽之外的步骤。
以下,根据所附图纸,更详细地说明本发明可取的实施例。图3a和图3b是用于说明根据本发明的半导体晶片清洗方法的图纸。参考图3a,首先,在配备半导体晶片(100)和含有预定清洁液的洗涤液(200)后,为了从半导体晶片(10 0)的表面消除污染源,晶片(100)的平坦区域(Flat Zone)(102)此时,晶片100的平坦区域102与洗涤器200的入口不相对的方向对齐。因此,半导体晶片(100)与传统方法一样,按A、B、C区域的顺序沉积在清洗组(200)中。在图3a中,箭头表示半导体晶片100的沉积方向。
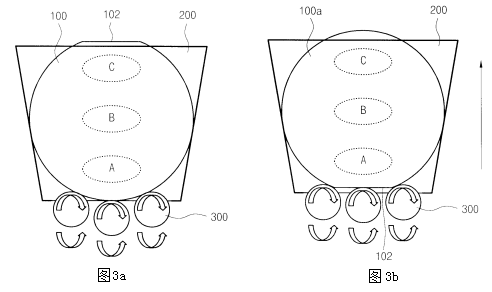
图3
另一方面,上述清洁液包含在半导体晶片(100)中形成的被清洁物,即氧化膜、聚合物、金属和有机物形式的薄膜,以及溶剂或化学溶液,以去除存在于半导体晶片(100)表面的颗粒形式的污染物。为此,上述清洁液最好含有H 2 SO 4、H 2 O 2、NH 4 OH、H 2 O、HCL、HF或溶剂。
参照图3b,为了防止上述流动性粒子缺陷现象,使用Rouller等预定的旋转手段,将半导体晶片(100)顺时针或逆时针旋转。此时,将半导体晶片(100)顺时针或逆时针旋转180°,以便半导体晶片(100)的平坦区域(102)与洗涤器(200)的入口相对。在图3b中,参考符号300指示半导体晶片100的旋转方向。
其次,旋转的半导体晶片(100a)在小定时期间保持沉积状态进行清洗。因此,通过对上述溶剂或化学溶液旋转的半导体晶片(100a)的表面作出反应,去除上述薄膜和颗粒形式的污染物等被清洗物。然后,清洗完成后,将那个清洗过的半导体晶片浸入清洗槽(200)之外。在图3b中,箭头指示半导体晶圆(100)脱离方向。在此,需要注意的是,本发明的工作实施例不仅适用于单张晶片,还适用于成批清洗复数晶片。
为了统一清洗复仇晶片的方法,可以使用盒式磁带。在这种情况下,将多个晶片安装在卡带上后,将多个晶片的平坦区域对准洗涤池的入口不面向的方向,将那些对齐的卡带浸入洗涤池中,进行上述一系列洗涤工。
虽然上述说明并阐明了本发明的具体实施例,但本发明由糖业者进行了多种变形,具有实施的可能性是不言而喻的。这些变形的实施例不应从本发明的技术思想或前景中单独理解,而应属于本发明所附专利申请范围内。如上所述,本发明通过在晶片浸泡在清洗组中的情况下向预定方向旋转,缓解晶片各区域的溶解速度差,防止流动性颗粒缺陷现象,从而实现均匀的晶片清洗,这不仅改善了元件的电气特性,还能产生增加元件收率的效果。