
扫码添加微信,获取更多半导体相关资料
引言
本文研究了CMP化学物质诱导的多孔硅-sio低材料的降解,并描述了其降解机理和回收方法。描述了CMP工艺对漏电流退化的影响和介电常数,发现漏电流和介电常数增加。根据傅立叶变换FTIR吸收,由于CHx和OH键的增加,CMP后清洗溶液,这是因为化学机械抛光后清洗溶液中的表面活性剂渗透到多孔二氧化硅中,渗透的表面活性剂在CMP工艺之后,可以通过用2-丙醇或乙醇冲洗来去除多孔二氧化硅。
实验
本文研究的工艺流程是使用CMP扫描机NPS3301尼康对300mm硅片上的多孔硅片进行了Cmp工艺直接抛光和CMP后清洗,将浆液的流量保持在150mL/min时保持不变,抛光压力和平均相对速度分别保持在0.34kPa和1.79m/s。这个多孔的二氧化硅被抛光了30秒,清洗液1�pH9.0和清洗液2�pH5.0与刷砂一起进行cmp后清洗,清洗时间分别为38和60s。此外,用n2气-水二相流动清洗清洗抛光后的多孔二氧化硅18s。
为了研究CMP化学物质的降解和对回收过程的影响,进行了浸渍试验,即将多孔硅膜浸入CMP化学物质中1min,用去离子水或乙醇冲洗8min,n2吹法干燥。FTIR作为一个指硅衬底在透射模式下的入射角和垂直入射角的差光谱进行测量。采用固着液滴法测量了接触角。利用可见光下光谱椭圆偏振法测量了po-SiO的薄膜厚度和折射率。
结果与讨论
在CMP工艺中,在去除阻挡金属后对帽膜进行抛光,以便对帽膜和阻挡金属必须具有相同的抛光速率。图4显示了使用帽CMP浆料的各种帽膜与阻挡金属Ta膜的抛光速率之比,其与阻挡金属的抛光速率相同。

图4 各种帽膜与阻挡金属�Ta膜的抛光速率比
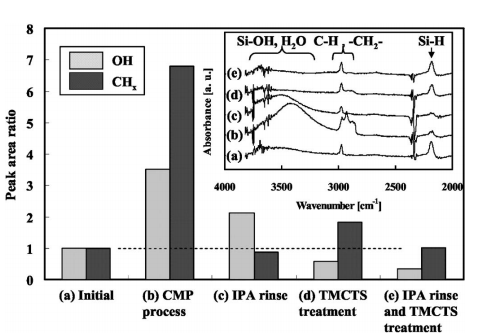
图5
图5显示了不同过程后,po-SiO的FTIR光谱中的吸收峰面积与初始值的比值。OH键和CHx的吸收峰面积分别在3100-3700和2800-3000cm−1处,得到了OH键和CHx的吸收峰面积。OH键和CHx的FTIR吸收强度随CMP过程的增加而增加。为了确定光谱变化原因的主要过程,将多孔二氧化硅浸入CMP浆液和CMP后清洗溶液中,用去离子水冲洗。在处理的每一步都测量了FTIR光谱,当将多孔二氧化硅浸入CMP浆液中时,羟键的吸收强度增加,而CHx的吸收强度没有变化。当多孔二氧化硅浸入cmp后清洗溶液中时,氢的吸收强度和CHx增加。cmp后清洗溶液含有表面活性剂和有机碱或有机酸。然后将清洗溶液与氢氧化铵�TMAH和乙酸氢氧化铵乙酸进行比较。
在得到的FTIR光谱中,CHx的吸收强度没有增加,只有当cmp后清洗溶液中的表面活性剂渗透到多孔二氧化硅中时,CHx的吸收强度才会增加。虽然浆液中也含有表面活性剂,但多孔二氧化硅的CHx吸收强度没有增加。这说明CMP后的去离子水冲洗可以去除CMP泥浆表面活性剂。
将多孔二氧化硅浸入CMP化学物质中后,氧化氢键的吸收强度增加,当多孔二氧化硅浸入乙酸时,氧化氢键的吸收强度与初始状态几乎没有变化,而浸入TMAH时吸收强度增加。由于cmp后清洗溶液1和TMAH溶液是碱性的,疏水基团�甲基和Si之间的化学键被碱性溶液破坏,多孔二氧化硅的疏水性降低。去离子水和乙醇冲洗CMP化学物质后,去离子水在多孔二氧化硅上的接触角相同,虽然用乙醇冲洗可以去除渗透的多孔二氧化硅表面活性剂,但接触角没有恢复到初始值,这表明多孔二氧化硅的疏水性降低。
在TDS光谱中,在CMP过程后400�时,如CH3�甲烯2O-�,70�、�-甲烯5-�,和88如�-CH2CH2O-�和600°C下渗透表面活性剂的解吸,在IPA冲洗后,去除在400和600°C下分离的元素。这证实了通过IPA漂洗液可以去除表面活性剂。因此,在CMP过程中,经IPA冲洗和TMCTS处理后,CHx和OH键的吸收强度均恢复到初始值。
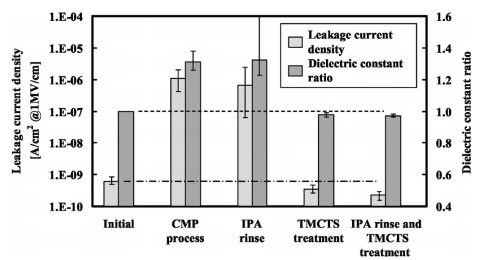
图11
图11为多孔二氧化硅经过不同工艺后,在1mv/cm时的泄漏电流密度和介电常数之比。CMP处理后,泄漏电流密度和介电常数均增加。CMP后的IPA冲洗液不能将泄漏电流密度和介电常数恢复到初始值。当CMP后应用TMCTS处理时,这些量被恢复到初始值。电学性能的恢复对应于氧化氢键的吸收强度的恢复。这些结果表明,多孔二氧化硅中的吸收水可降解了多孔二氧化硅的泄漏电流密度和介电常数。
同时比较了多孔二氧化硅浸入浆液中、cmp后清洗、超音速清洗和乙醇漂洗前后的小角度x射线散射光谱,小角度x射线散射谱与多孔材料中孔隙的大小和分布有关。这些处理后没有观察到变化,表明多孔硅性能的恢复和降解,孔隙结构没有任何明显的变化。
由于cmp后清洗溶液中的表面活性剂渗透到多孔二氧化硅中,导致水的吸附,泄漏电流和介电常数均有所增加。可以去除渗透的表面活性剂 CMP工艺完成后,用IPA和乙醇冲洗。通过TMCTS处理,可以恢复泄漏电流密度和介电常数的降解,从而恢复了孔壁表面的疏水性。