
扫码添加微信,获取更多半导体相关资料
引言
本文介绍了一种用于去除颗粒的化学机械抛光清洗剂,该清洗剂由氟铝氧离子螯合剂和氟铝氧离子表面活性剂组成,通过改变刷子转速、刷子间隙和去离子水流量等参数,进行了一系列实验,以确定最佳清洗效果。原子力显微镜(AFM)测量用于表征铜表面的表面形态和磨粒的去除,用EDX扫描电子显微镜观察和分析了颗粒的形状和元素,获得了化学机械抛光清洗剂的最佳参数。在这些条件下,二氧化硅磨粒被有效去除,提出了刷式洗涤器清洗是CMP清洗剂中最有效的方法,具有较高的物理力清洗性能。
实验
所有实验均采用300mm覆盖铜晶片切出的铜片(直径10.16mm),抛光过程采用CMP抛光器进行,工作压力为2psi,压头速度/压板速度为55/60rpm,浆液流量为150ml/min,抛光时间为10s,随后采用CMP清洁剂(G&P,412S)进行铜片处理,清洗液包括FA/OII螯合剂和FA/OI表面活性剂。清洗机在刷子上方有两个独立的喷雾棒,清洗液或DIW从喷雾棒流出,并通过刷子芯流出。
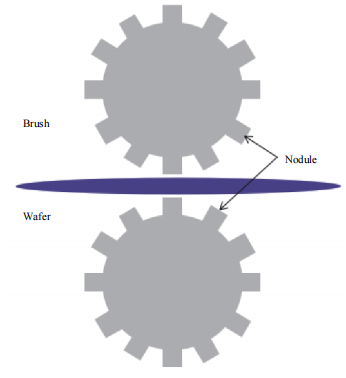
图1
如图所示1,晶片水平地位于刷子清洗盒中,喷雾棒在刷子的上方,清洗液或DIW从喷雾棒流出,并通过刷芯流出,将转速、清洗时间和电刷间隙作为这些实验的变量,刷状间隙定义为晶片表面与刷状结节之间的距离,间隙越小,对晶片的压力就越大,采用原子力显微镜测定其清洗性能。由于阻挡浆中的过氧化氢,铜在晶片表面被氧化形成铜/铜氧化物和羟氧化物钝化,FA/OII螯合剂是一种有效的碱性螯合剂,具有13个螯合环,可缩短为R(nh3)4,FA/OII螯合剂与cu-sio2生成的Cu2+/Cu+反应并切割Cu-sio2键有影响,如图所示2。
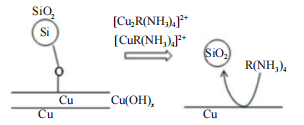
图2
该产品是可溶的,可以很容易地从铜表面带走,由于酸碱中和,SiO2可以与R(NH3)4产生的OH-反应, FA/O表面活性剂分子可以穿透颗粒和铜晶片表面之间,并在表面上扩散 前清洗,铜晶片的SEM图像和EDX分析表明,大部分是抛光浆中的磨磨硅颗粒。为了有效地去除颗粒,我们进行了一系列的实验,研究了CMP清洁剂的参数,该表面活性剂的分子吸附层的形成减少了颗粒与晶片表面的接触面积,导致二氧化硅颗粒的解吸。
结果与讨论
图3显示抛光铜表面的AFM图像。 表面粗糙度反映了表面形态的波动,晶圆和刷子之间的摩擦力也增加,这增加了拖曳力,使磨料硅颗粒更容易从晶圆上去除,当刷隙大于0.75 mm时,铜的表面粗糙度值没有提高,其原因可能是,如果施加高压,颗粒将更深地穿透晶圆表面,并变得更难去除。
本文研究了颗粒去除的最佳工艺条件,该条件可作为后续研究的基本参数,以确保实验的准确性,DIW流动时间短,DIW流动的较长时间有利于颗粒残留物的去除,SEM图像和EDX分析验证了磨料硅颗粒被有效地去除。化学机械抛光后,大部分二氧化硅磨粒残留在铜表面,严重影响半导体器件的性能和成品率。本文对pa进行了研究用于去除颗粒的化学机械抛光清洁剂的参数,实验结果表明,当刷子的转速为200转/分,电刷间隙为0.75毫米,DIW流量时间为120秒,研磨的二氧化硅颗粒被去除,在此条件下,原子力显微镜结果表明,表面粗糙度值为1.08纳米,SEM测量进一步证实了这一结论。