
扫码添加微信,获取更多半导体相关资料
本文介绍了防止金属和微粒子粘附到晶圆表面的表面活性剂添加药液、螯合剂添加药液、以及能够比以往的BHF更精确地蚀刻各种氧化膜的氟化物添加的低介电常数溶剂。
半导体器件是在硅基板上全面形成金属和绝缘膜的薄膜,只蚀刻除去必要的部分,从而形成图案而制作的,要形成高质量的薄膜,基板的高清净化是非常重要的要点,另外,为了实现高集成化,薄膜的正确蚀刻除去是非常重要的要点。图1所示的接触孔底部的自然氧化膜通过湿法工艺去除的情况下,掺杂氧化膜和非掺杂氧化膜同时与蚀刻液混合就会暴露。 因此,正确控制各种氧化膜的蚀刻速率变得非常重要,通过使用相对介电常数低的溶剂代替一般作为BHF溶剂使用的水来抑制HF和HF2-的解离,其结果,介绍了只能够选择性地蚀刻掺杂氧化物膜的结果和能够使非掺杂氧化物膜和掺杂氧化物膜的蚀刻速率达到等速的结果。
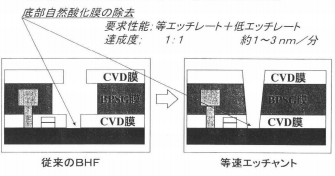
图1 接触孔底部自然氧化膜的去除
图2显示的是BHF中的NH、F浓度与BSG膜、热氧化膜(THOX)的蚀刻速率、以及被预测为蚀刻种类的HF、HF2浓度之间的关系。 虽然详细的蚀刻机理尚不清楚,但可以预测,掺杂了三价杂质B的BSG膜的蚀刻种类以HF为主体,仅有Si-o键的热氧化膜的蚀刻种类以HF2一为主体。 已知溶解离子性固体的液体的能力高度依赖于液体的相对介电常数,1价阳离子和阴离子间的吸力与相对介电常数成反比,上述缓冲氢氟酸的溶剂是水,水在25℃下的相对介电常数约为78,是容易引起相对介电常数高的离子解离的溶剂。
可以认为,在添加了HF的低介电常数溶剂中,选择比高的理由是,与水相比,HF的解离几乎不发生,其结果是实现了几乎不存在HF2的仅有HF的体系。 在添加了NH、HF的IPA以及乙醇中,得到了基本满足该条件的结果。这些选择性蚀刻剂、匀速蚀刻剂将被引入到将来的微细化、高集成化的半导体制造工艺中。
表面活性剂由分子内不容易与水相适应的疏水基和容易与水相适应的亲水基组成,具有定向于气体/液体、液体/液体、液体/固体等两相界面,降低其表面张力或界面张力的功能。
图3中,HF浓度为6mass%,NH、F浓度为30,对于mass%的代表性缓冲氢氟酸,显示了表面活性剂添加浓度与润湿性指标表面张力、与光刻胶的接触角之间的关系,如该图所示,随着表面活性剂添加浓度,缓冲氢氟酸的润湿性不断提高。 由于缓冲氢氟酸是抗蚀剂难以浸湿的液体,因此在进行以抗蚀剂为掩膜的氧化膜图案蚀刻时,需要进行抗蚀剂的亲水化处理。
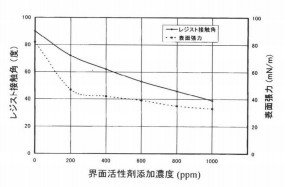
图3 表面活性剂添加浓度与润湿性的关系
图4显示的是在HF浓度为L6mass%、NH4F浓度为39mass%的i:30BHF中浸泡CZ―N(100)硅晶圆10分钟时的AFM图像照片。 在图4中,BHFi30U、BHF130U1显示含有表面活性剂,这些含有表面活性剂的缓冲氢氟酸没有增加硅表面粗糙度。 可以预想,在硅基板出现的湿法蚀刻处理(阱的开口蚀刻等)中,通过使用加入表面活性剂的缓冲氢氟酸,可以改善上部形成的氧化膜的电特性。
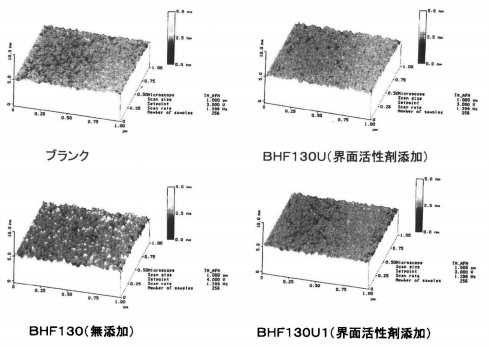
图4 硅表面的AFM图像照片
通过添加阴离子体系可以抑制晶片背面污染粒子向相邻晶片表面转移的例子中, 实验使用2片硅晶圆,已知向药液中加入表面活性剂,特别是阴离子类的加入,对于防止药液中的颗粒污染晶圆表面和晶圆背面颗粒的转移是有效的。
为了解决氨-过氧化氢水清洗在去除晶片上的颗粒污染和有机物污染方面发挥优异效果的问题,由于金属污染去除能力差,如果液体中存在痕量的Fe、Ai等金属,则会大量附着在晶片上,在氨-过氧化氢溶液洗涤后,为了去除从洗涤液中附着的金属污染,使用盐酸-过氧化氢溶液洗涤,但有报告称,通过向氨-过氧化氢溶液中加入螯合剂,可以省略以前使用的盐酸-过氧化氢溶液洗涤,以防止Fe、Ai等金属污染。
可以认为,湿法工艺在去除粒子污染、金属污染、有机物污染、自然氧化膜方面是有效的,另外,从湿法工艺特征的简便性、批量生产性这一点来看,今后也将在半导体制造工艺中广泛使用。 在湿法工艺中使用的药液,为了在清洗蚀刻时不污染晶圆表面,需要尽量减少金属和微粒子的高纯度的药液,强烈希望开发出除了高纯度之外,不将金属微粒子附着在晶圆表面的药液和高精度地蚀刻薄膜的高性能药液。
在此,介绍了作为高性能药液,防止金属和微粒子附着于晶圆表面的表面活性剂添加药液、螯合剂添加药液的最新开发状况。 另外,介绍了在添加氟化物的低介电常数溶剂体系中,可以比以前的氧化膜蚀刻中使用的缓冲多丁酸更高精度地蚀刻除去各种氧化膜。而关于用于湿法工艺的药液,可以认为今后将进一步开发出具有功能性的高纯度药液。