
扫码添加微信,获取更多半导体相关资料
引言
我们报道了一种紫外(UV)光刻和直接书写的方法,其中曝光模式和剂量都是由互补金属氧化物半导体(CMOS)控制的微像素化发光二极管阵列决定的。来自演示器8x8氮化镓微像素LED的370nm紫外光使用两个背对背显微镜物镜投射到光刻胶覆盖的基底上,允许控制去除。在目前的设置中,该系统能够在直径为~8µm的圆形点中为每个成像像素提供高达8.8W/cm2。我们展示了用正光刻胶和负光刻胶书写的示例结构。
光刻技术是微图案化的首选方法, 按照最近报道的方法设计了CMOS控制装置,使交替像素可操作,从而得到了一个发光的8x8阵列[图]1(a)]。这是由于凹凸键合过程,目前限制了像素到像素间距为~200µm。
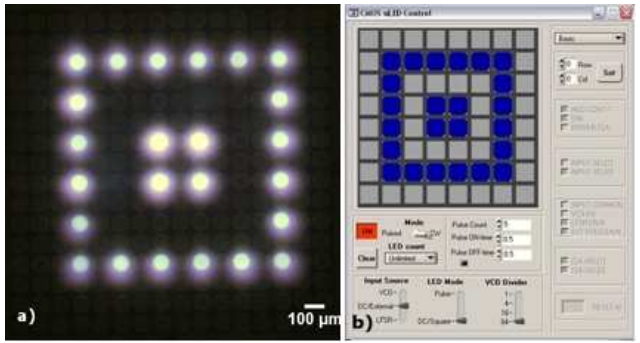
图1
CMOS装置允许单个微像素、方波和脉冲操作[8]的连续波(CW)操作。在CW操作中,我们测量了一个裸像素,在370nm的驱动电流为80.0mA(340µW在20mA)下提供高达604µW的光功率。方波的频率(脉冲模式下的重复频率)可由片上电压控制振荡器(VCO)从6MHz到800MHz之间设置,使用外部时钟设备,可以选择任何频率,在脉冲模式下,可以控制脉冲的持续时间,范围从300ps到40ns。成像后测量的27mA的光谱特征证实其接近Hgi线操作(峰值在370nm,FWHM为15nm)。
CMOS控制装置连接到印刷电路板(PCB)上,通过现场可编程门阵列(FPGA)板进行计算机控制,在定制的软件界面中,如图所示1(b),CMOS芯片的操作模式可以设置为线性反馈移位寄存器、直流/外部或VCO,LED模式可以设置为DC/Square或脉冲,VCO分频器设置一个值(1、4、16或64),在使用VCO频率之前对其进行划分。通过设置行和列,可以选择由一组像素组成的像素或模式,1(b)]或通过在软件界面的网格模式中突出显示所需的像素,通过定时控制,LED准时可以准确地设置到~100ms,在图中可以看到无掩模光刻装置的摄影图像和相应的示意图。关于分束器的方向。无限校正物镜在焦平面上给出物体的准直(或平行)输出光束,因此当相机物镜设置为无穷大聚焦时,相机上显示的图像光学共轭到每个物镜的焦平面。
用于投影显微镜物镜z平移的压电驱动台(PIP-725.4CD)提供了非常精确(100nm分辨率与当前驱动和反馈测量系统)的焦点控制。样品放置在XY级(2xPIM-112.1DG)上,允许大面积(高达25x25mm2)形成图案。计算机控制允许样品以任何预定义的模式以最大速度为1.5mm/s移动,重复性为~1µm。
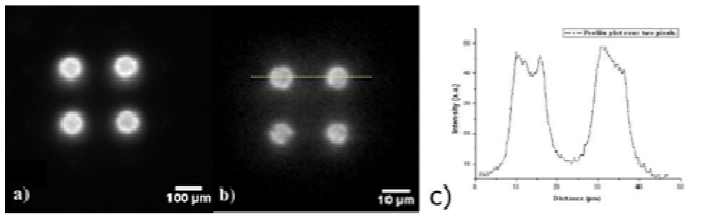
图 3
这两个目标可以改变,以提供放大或去放大从LED像素的投影点的能力,当投影微led设备的72µm直径像素时,一系列从4X到40X放大倍数的显微镜物镜给出了从7.2µm(4X采集物镜和40X投影物镜)到720µm(40X采集物镜和4X投影物镜)的理论光斑尺寸,通过4X采集物镜可以看到4个像素。3(a)并通过40X采集物镜在样品位置的镜子上反,3(b)]显示系统如何识别被照亮的点。
为了表征系统的性能,通过在样品位置放置一个校准的紫外光功率计(相干场MaxTop)来测量在样品处交付的每个像素的光功率。总投影功率用40X采集物镜测量为140µW,用4X采集物镜测量为4.4µW,均在~的CMOS驱动电流下获得。投影功率独立于投影目标,因为传输损耗很低,并且对于这类目标非常相似。测量结果还表明,在整个系统中只有很小的传输损耗(大约小于4%),除了分束器的~功率损耗为50%。投影的斑点大小是通过成像放置在样品位置的镜子上的反射来确定的。

图4
图4显示了在9.75MHz的固定重复频率下,平均投影光功率如何随脉冲持续时间从0.5ns到40ns而变化。功率呈线性尺度,但LED的脉冲驱动允许我们探索光阻的间歇固化行为。CMOS驱动程序的这一特性原则上还可以用来纠正像素之间的输出功率的差异,并补偿视场上的收集效率的变化。
为了测试微光刻系统,在正光刻胶和负光刻胶中都产生了许多不同的“演示剂”图案。Norland(NOA81)选择了一种光学粘合剂,因为其粘附于玻璃,粘度相对较低,使薄膜可以在基底上旋转,因此提供了少量µm尺寸的可能性。该光学粘合剂的光谱峰灵敏度为365nm,制造商推荐的完全治疗剂量为2J/cm2,在制备过程中,硼硅酸盐玻璃的衬底在丙酮和甲醇的超声浴中彻底清洗,然后将它们用去离子(DI)水中冲洗,并在110°C的热板上干燥至少20分钟。然后,NOA81在8000rpm下旋转涂覆40秒,通过固化结构上的触控笔(DekTak)轮廓仪测量的薄膜厚度为1.7µm。将带有诺兰薄膜的衬底放置在XY台上,然后通过通过该装置投射的微led装置的紫外光曝光。
在LED装置的脉冲操作下,对NOA81进行了进一步的固化实验,通过将脉冲宽度从5ns改变到40ns,从而将暴露剂量从16.4J/cm2改变到120J/cm2,可以写入从11µm到24µm直径的斑点大小,曝光时间为40s。
对于正极光刻胶的特征,标准光刻胶,希普利微阳性S1805。它对g线(436nm)曝光进行了优化,但对350nm的曝光波长效果良好。线的推荐暴露剂量为150mJ/cm2。硅基底在丙酮和甲醇的超声浴中彻底清洗。然后用去离子水冲洗它们,并在110°C的热板上干燥至少20分钟。光刻胶以2000rpm的转速旋转30秒。然后将含有0.7µm厚薄膜的基底置于120°C的热板上1分钟,以软烘烤光刻胶后再暴露。暴露后,使用微显影剂溶液(微阳性与去离子水的1:1体积比)完成开发,将基质浸泡后,在溶液中轻轻移动1分钟,用去离子水冲洗去残留的显影剂。
作为进一步的演示模式,我们用较厚的正型光刻胶书写,来自希普利的微阳性S1818。玻璃基底的清洗方式与以前的样品相似,随后用旋转涂层用~2.0µm厚的光刻胶覆盖,然后将样品在脉冲模式下同时暴露4个像素,持续2秒,暴露剂量为1.1J/cm2,将样本翻译成40µm,并进行其他暴露。这被重复了四次,然后是如上所述的开发步骤。
通过将新型CMOS驱动的微led阵列与投影系统相结合,我们建立了一种多功能的计算机控制的微光刻工具,能够将正负光刻胶的特征写到~8µm。它能够同时暴露多个斑点,并通过CMOS驱动机制,能够精确控制在一段确定的时间内传递的剂量,并能够纠正整个视野的不均匀暴露。这种类型的系统为直接写光模式和模式光刺激的许多领域提供了有吸引力的前景,包括聚合物微结构、无掩模光刻、数字光学化学、微流控系统和光遗传学。