
扫码添加微信,获取更多半导体相关资料
引言
在硅衬底上制造电子芯片或集成电路需要大量的基本操作,例如离子注入, 本研究将涉及光刻,介质和金属薄层沉积,机械化学抛光,热处理(退火或氧化)和“湿”处理。
表面准备和清洁是这项技术的一个有点吃力不讨好的方面,因为它们是“看不见的”: 它们包括去除污染物和控制界面,然而,在需要处理的层是纳米级的时候,我们注意到与这些方面有关的研究变得至关重要,并对“专门知识”作出了重大贡献,而“专门知识”有时很难得到重视。
一些选择性蚀刻是通过湿法(在溶液中)进行的,具有很高的精度,厚度变化从几埃到几微米。 “表面准备”处理允许 本备忘录中讨论的两个主题更具体地涉及集成电路互连电平的清洁: 首先,将介绍低或极低介电常数介电材料在清洁溶液中的行为研究。 特别是,我们研究了这些材料的稳定性或溶解性,以及液相中的污染现象(胺,有机化合物和来自清洁溶液的表面活性剂的吸附),这些现象导致电介质的相对介电常数的不期望的变化。 研究了它们的孔隙率随清洁处理(含氢氟酸的溶液)中使用的等离子体处理的变化。 在这一部分中使用的实验技术主要是椭圆偏振法,椭圆孔隙率法,红外光谱法(透射法,全衰减法和多重反射法),X射线反射法,TOF SIMS以及接触角和允许性测量。
性能竞赛
在微电子领域,金属氧化物半导体(CMOS)类型的硅衬底上的集成电路的技术发展被描述为“Neud technologique”,该“Neud technologique”对应于所制造的最小晶体管的栅极尺寸。 因此,提高集成电路性能的两个主要研究因素是晶体管的开关速度, 另一方面,电路功能的增加与电路中集成的晶体管数量的增加有关。 性能竞赛导致了电路小型化竞赛,由一个由工业和学术专家组成的国际委员会制定的规范严格控制,并以国际半导体技术路线图(ITRS)的名义公布。 这些规范定期审查和更新,以考虑到 真正的进步和仍然存在的困难。
同时,硅衬底尺寸从4英寸逐渐增大到12英寸(300mm),使该工艺在很大程度上有利可图,每片可实现多达200个芯片,并说明了在硅锭生长中获得的控制。 然而,由于不同尺寸的基材的生产设备的发展,也出现了新的技术和工业问题。
简单地说,集成电路由两个主要部分组成(图1): 有源部分,也称为线前端(FEOL),对于在硅衬底中制造的晶体管。 互连级,或BEOL,用于将晶体管连接在一起。 它们由金属线组成,通过圆柱形“通孔”相互连接,并嵌入绝缘材料中。 今天达到的晶体管密度需要能够使连接它们的线交叉,这导致互连水平成倍增加。 例如,为65nm技术制造了7个金属能级。
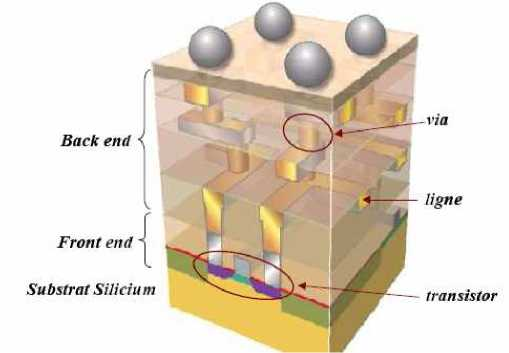
图1电路集成的表示方案
除了晶体管和互连线之外,还可以在FEOL部分或BEOL部分中找到诸如板载电容之类的元件,这取决于技术NUD。 此外,最近直接在硅衬底上的图像传感器的发展现在导致了系统的复杂性,以便在晶体管处集成光电二极管,在最后的铝BEOL互连处集成滤色器和微透镜,或者在衬底的背面上集成光电二极管。
互连水平:不同技术节点规格的演变,有两个主要因素有助于电路的响应时间,晶体管的开关时间和信号在互连中的传播时间。
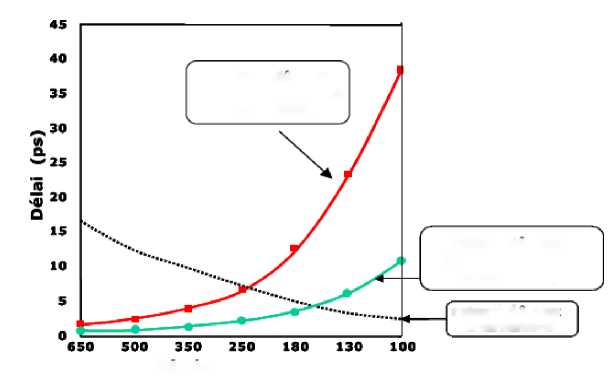
随着晶体管和互连网络的临界尺寸的减小,对于使用铝作为金属和使用氧化硅作为金属间绝缘体的技术,这两种贡献的相对重要性从Neud 250nm开始反转(图2),这是因为尺寸的减小而且彼此越来越接近促进了两个相邻线路之间的电容耦合。因此,减小与互连中的信号传播相关的延迟迅速成为一个突出的问题。 在一阶上,它取决于构成导电线的金属的电阻率和线间绝缘体的相对介电常数(或介电常数),铜和低介电常数(Low-K)电介质从120纳米技术NUD中被引入,以取代铝和SiO2。
结论和展望
整个工作证明了SiOCH型低介电常数介电材料在气相中和在液相中与非极性有机分子和表面活性剂的高亲和力。 从实际的角度来看,这导致了整合方案的修改,并将清洁化学物质的选择导向水溶液,该水溶液主要由稀释的有机酸组成,作为基于稀释的HF的方法的补充,该方法可以保存到Neud 40nm。
关于多孔介质,我们进一步证明: 在等离子体蚀刻处理之后,在材料的表面上形成更致密的5nm至10nm的层,具有减少的孔隙率,然而,该层对气体扩散不是密封的。 根据所使用的不同探针分子,该层的选择性在一阶上与气体和固体之间的极性相互作用有关,而不是与分子的尺寸有关清洁处理和硅烷化类型的最终表面功能化。
蚀刻后清洗的挑战:蚀刻残留物的特性
在实现集成电路互连水平时,最关键的清洁是那些底层的铜暴露在所使用的化学物质中的清洁工作。(2)在实现集成电路互连水平时,最关键的清洁工作是那些底层的铜暴露在所使用的化学物质中的清洁工作是那些底层的铜暴露在所使用的化学物质中的清洁工作。 实际上,金属的任何过度腐蚀都可能导致器件的电性能和可靠性的严重退化。 例如,在“鸟嘴”型缺陷的情况下(图27),由于铜的溶解而在电介质下方产生的真空将导致可靠性问题。
首先,通过俄歇效应XPS和TOF SIMS光谱分析蚀刻O3图案后留在铜表面的残留物(图28),先前的研究[31,32,3]表明,在使用氟碳等离子体蚀刻电介质后,在图案的侧面上留下的残留物主要由CFx(x=1-3),CH,Co键组成,并含有等离子体溅射铜。 在铜上检测到CuFx物种。 与这项工作相一致的是,我们对大面积铜进行的分析表明,碳,氟和氧含量很高,特别是XPS证实了CuO型氧化铜层的形成。
在清洗过程中去除这些残留物对于确保两个金属层之间的良好导电是必不可少的。 由于它们的性质,很难知道它们是否可以直接溶解在清洁溶液中,或者它们是否可以通过溶解氧化铜和可能的轻微蚀刻铜来去除,这有助于它们的脱落。对铜的腐蚀和氧化铜在清洗液中的溶解感兴趣是非常重要的。 将特别注意通过限制金属铜的溶解来快速溶解氧化物。