
扫码添加微信,获取更多半导体相关资料
本文利用流电位技术测量了不同清洗过程下低压和等离子体增强化学气相沉积氮化硅晶片的电动学特性,一个用于处理5in的流媒体电势单元,设计和制造晶圆是为了进行这些测量,氮化硅的等电点(IEP)取决于清洗方法和沉积技术,用x射线光电子光谱测量了薄膜的Si/O和Si/N比,以解释测量到的IEP值的差异,研究了聚苯乙烯乳胶颗粒从水溶液沉积到氮化硅晶片上,并与电动势数据的相关性。
晶圆是专门为zeta电位测量而设计和构造的,是由两个超高分子量聚乙烯(UHMWPE)块构建的,每个块都有一个精确的切割凹陷,取5英寸,封信条用直径为14.7cm、厚度为0.076cm的聚四氟乙烯(PTFE)垫片分离氮化硅晶片,在垫片的中心切割一个0.814.2厘米的区域,形成一个液体流动通道,顶部块有合适的液体入口和电极放置,如图所示1,两个铂铂电极位于电池的顶部,以测量流电位,铂电极用掺杂0.005%(w/v)氯铂酸溶液定期铂化,以减少极化产生的不对称电位。
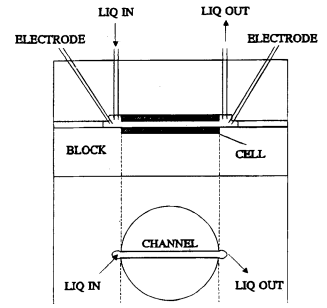
图1
本研究采用以铝阳极(K~1.2=1486.6eV)为x射线源的VGscalabMKII光电子能谱仪进行XPS分析,用PerkinElmer1800傅里叶变换红外光谱仪在800~4000厘米-z区域获得了氮化物晶片的傅里叶变换红外(FTIR)光谱,在测量过程中,用氮气净化样品室,以减少含水量。20次分辨率为4cm-1的扫描结果为信号平均。

图2
利用傅里叶变换红外透射技术首次测定了等离子体化学气相沉积氮化物晶片的氢含量。图2显示了PECVD氮化物晶片的傅里叶变换红外光谱,从氮氢和硅氢分别在3350和2160厘米-1拉伸时的强吸收峰可以看出大量键合氢的证据,可以看出,LPCVD氮化物晶片的IEP值根据清洗工艺在3.5至5.3之间变化,用食人鱼和RCAl清洗的晶片显示的IEP值分别为3.8和4.5。通过不同方法清洗的LPCVD氮化物晶片的ζ电势作为溶液pH的函数,可能会出现这种情况,结果表明,二氧化硅薄膜的IEP值在ph2.8 ~3.5范围内,用食人鱼清洗氮化物晶片的IEP。
图中在食人鱼中清洗的氮化物晶片上的PSL粒子数量随着pH值的降低而增加,并且在晶片的IEP值(3.8)附近急剧变化,在晶片具有正ζ电势的酸碱度下,沉积似乎是有利的。 为了解释通过不同程序清洗的LPCVD氮化物膜的IEP值的差异,使用XPS测量了清洗过的晶片表面的硅氧比和硅氮比,通过确定每种元素的峰下面积除以原子灵敏度因子来计算原子密度,对于N (1s)、O (1s)和Si (2p),原子灵敏度因子分别为0.42、0.66和0.27,结果表明,由食人鱼清洁的氮化物膜具有最大的Si/O和N/O值(最低的O含量),在这个理论中,浸没在液体介质中的粒子和表面之间的相互作用能量由两部分组成,一个是由于双电层相互作用(可能是排斥的或吸引的),另一个是由于范德华相互作用(总是吸引的)。
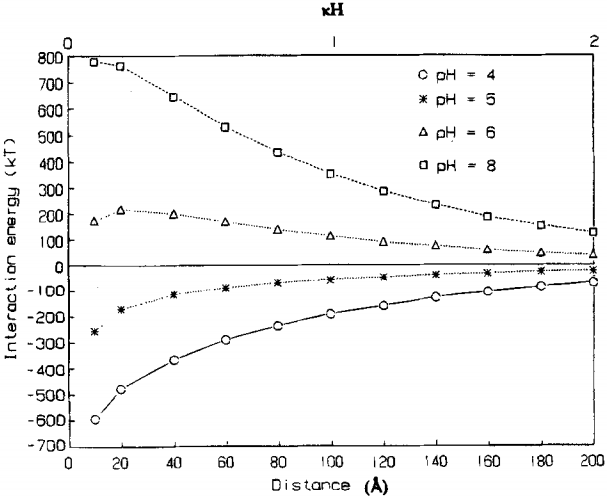
图9
图9中绘出了PSL粒子和由食人鱼清洗的氮化硅晶片之间的相互作用能量分布,随后是BOE (IEP = 5.3),对于小于IEP值的pH值,相互作用能为负 (5.3)对于大于5.3的酸碱度,存在排斥势能垒。因此,这些氮化物晶片的颗粒污染在pH值较低时可能是有利的。用流动电位法对LPCVD和PECVD氮化硅薄膜进行了表征,结果表明氮化硅薄膜的IEP取决于清洗处理,LPCVD的IEP和被食人鱼清洗过的PECVD晶圆分别是5.3和4.9,很可能代表了氮化物晶圆的真实IEP,用XPS测定的硅氧比和硅氮比表明,IEP值受清洗过程中氧化程度的影响。水溶液中PSL粒子在氮化物晶片上的沉积与zeta电位数据相关。PSL粒子和晶片之间的静电相互作用似乎是污染的一个促成因素。