
扫码添加微信,获取更多半导体相关资料
在本研究中,原子力显微镜(AFM)已被用来生成纳米尺度的网格线,并将其转移到感兴趣的材料中,AFM诱导的硅局部氧化是一种具有强大的近端探针纳米制造潜力的过程,本研究讨论了蚀刻温度、蚀刻深度和线宽之间的关系,并介绍了超声搅拌来提高表面粗糙度和纳米结构的形貌,最后,对优化后的纳米网格线结构进行了验证。
所有实验均采用(110)取向硅片进行,硅衬板的电阻率约为1~10欧姆-厘米,样品的制备方法如下:标准RCA清洗,去除天然氧化物,在5%氢氟水溶液中钝化氢,然后用SPL进行局部氧化过程,SPL是在使用Park科学仪器(PSI)自动探针M5原子力显微镜(AFM)的空气中进行的,使用高掺杂硅悬臂尖端(尖端半径约为10~15nm,电阻率约为0.01~0.025ohm-cm),尖端/样品力保持在10nN(~0.01μm高度),尖端和样品之间的电压偏差产生电场,迫使电子和负移动离子(O-)进入样品中。
在局部氧化后,引入取向依赖的蚀刻工艺,获得纳米级纳米结构,由于晶体平面不同,化学键量不同,因此(111)平面的蚀刻速率最慢,导致与其他晶体平面的各向异性蚀刻。在本研究中,还引入了超声波搅拌(43kHz),以提高蚀刻过程的表面粗糙度和均匀性。最后,利用扫描电子显微镜(SEM)对其表面形态进行了表征,并进行了纳米尺度线宽的测量。
为了利用氢氧化钾湿蚀刻系统对硅纳米结构进行优化,研究了扫描探针光刻(SPL)的条件和氢氧化钾蚀刻系统的温度效应,研究了扫描速度和针尖/样品偏置对局部氧化的影响。环境湿度和恒定力保持在45±1%和10nN,在此条件下,AFM系统的物理模型类似于无限导电平面上的点电荷。

图1
图1显示了施加的尖端电压变化在-6V到-10V之间的结果,扫描速度保持在1μm/sec,在图1中,总氧化物厚度与尖端偏置成线性正比,扫描速度(曝光时间)的影响也被发现在尖端偏差-10V,当扫描速度太快(即曝光时间过短)时,氧化物的厚度非常接近于尖端偏置-9V。
图3显示,氧化物的厚度是由扫描速度确定的,尖端的偏差等于-8v,在图3中,随着扫描速度的增加,氧化物的厚度呈指数衰减,为了获得纳米结构的最佳长宽比,以下ODE过程的氧化物厚度为3nm,从图1和图3的结果来看,-8V的尖端偏置和1μm/sec的扫描速度是生成这种氧化物模式的最佳条件。
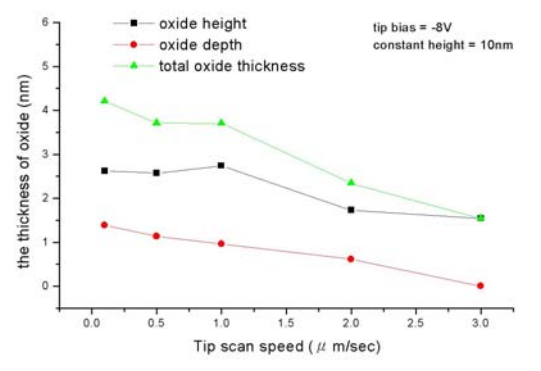
图3
传统的氢氧化钾蚀刻系统包括搅拌机、加热器和热电偶,由于该反应物不能有效地从蚀刻表面转移出来,因此这些仪器不适合进行纳米尺度的蚀刻过程。当采用传统的氢氧化钾蚀刻系统时,随着线/空间图案变小,表面粗糙度和形貌变差,当网格线间距较大(约1μm)时,表面粗糙度不明显,当螺距缩小到0.6μm时,表面粗糙度和形貌变差,为了减少粗糙度的增加和形态学的恶化,由于反应物可以有效地改善表面,表面粗糙度和形貌,表面粗糙度和形貌得到改善。
根据SPL条件和湿氢氧化钾蚀刻参数的控制,高191.2nm、宽19.69nm(长宽比10:1的纳米线),我们已经成功地将扫描探针光刻(SPL)和氢氧化钾湿取向依赖的蚀刻集成在纳米制造中,我们还证明了改进的氢氧化钾蚀刻系统为纳米尺度结构提供了较高的蚀刻性能,制备了临界尺寸(CD)可达20nm,长宽比可达10:1的纳米结构。人们认为,使用SPL和ODE工艺可以广泛应用于纳米制造,纳米器件,纳米机电系统(NEMS),甚至在生物技术中的应用。