
扫码添加微信,获取更多半导体相关资料
本文介绍了在半导体制造过程中进行的湿法蚀刻过程和使用的药液,在晶圆表面,为了形成LSI布线,现在几乎所有的半导体器件都使用干蚀刻方式,这是因为干法蚀刻与湿法蚀刻相比,各向异性较好,对于形成细微的布线是有利的。
湿法蚀刻是对膜进行各向同性蚀刻,因此不利于形成精细的布线,能够使用的布线有限,在最上层的Al系布线中使用的情况,这是因为与干法蚀刻相比,可以用廉价的装置形成。另外,在形成接触孔和通孔孔时,为了改善其后成膜时的覆盖范围,有的情况是首先用BHF药液进行湿法蚀刻;另一方面,在现在的半导体器件制造工艺中,作为最多的使用目的,还是去除布线形成后不需要的膜。
下面介绍半导体制造过程中的重要组成部分:清洗和使用药液,下列的表中。首先是粒子去除(清洗),通常使用的药液是氨和过氧化氢水的混合液,混合比例、液温、清洗时间等是各公司的专有技术,一般来说氨:过氧化氢:纯水=1:1-10:20-100,温度40-70℃,使用时间为30秒-4分钟。

下图中显示了粒子、金属杂质、有机杂质被清洗的机理的例子;在APM液中过氧化氢水的作用下,硅晶圆表面形成0.8 纳米左右的极薄氧化膜,使用臭氧水(臭氧浓度10 ppm左右,温度25℃以下)时,由于臭氧的作用,同样会形成0.8 纳米左右的极薄氧化膜,并且,APM液中的氨具有蚀刻去除形成的氧化膜的作用,在去除氧化膜的同时,粒子,金属杂质和有机杂质也将通过提升作用被去除,因为APM液是碱性的,所以粒子等杂质和晶片同样带负电,利用彼此分离作用的Zeta电位理论在药液的选择中也很重要,在利用臭氧水的情况下,使用1%以下的薄氢氟酸水作为臭氧水处理的下一个处理。
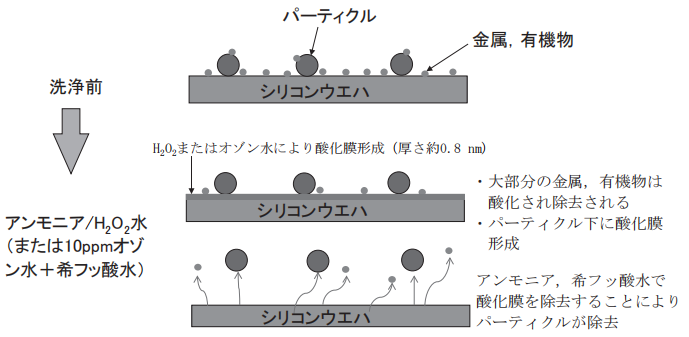
接下来是金属去除(清洗),需要利用氧化溶解机制去除金属成分,一般情况下,使用盐酸和过氧化氢水的混合液(简称HPM)、硫酸和过氧化氢水的混合液(简称SPM)的情况较多,在60℃以上的高温下使用,以提高氧化和溶解效率,另外从高性能和降低成本的观点来看,具有仅次于氟的高氧化势的臭氧水(臭氧浓度约10 ppm,25℃以下)也被广泛采用。
下面就有机物去除(清洗)进行论述,除光刻胶外,作为附着在晶圆表面的有机物,几乎没有大的固体状物质,因此,粒子和金属不纯 通过用于清洗物体的APM和HPM(或SPM),有机物也被去除清洗。
最后,关于一般制造很多半导体器件的公司、研究机构所采用的清洁配方,按照APM→纯水护发素→HPM(或SPM)→纯水护发素→干燥的顺序进行清洁构成,通过该配方,粒子、金属·有机杂质几乎全部可以清洗。
下面介绍一下清洗装置;清洗装置分为总线式清洗装置和单叶式清洗装置两类。总线式清洗设备的优点,毕竟是与单叶式清洗设备相比,晶圆生产率更高,25片或50片晶片一次性投入浴缸内清洗;另一方面,缺点是粒子性能与枚叶式相比较差的情况较多,也就是说,在总线式中,附着在晶圆表面的粒子在清洗槽内暂时离开晶圆,该粒子存在于槽内的药液和纯水中,之后,将晶圆移动到下一个清洗槽时,晶圆被提升到槽内液的上部,此时,槽内的粒子再次附着在晶圆表面的情况较多。
为了除去槽内的粒子,使其通过过滤器进行液体循环,但是现在还不能完全用过滤器除去粒子,另外,其缺点是药液·纯水消耗量比单叶式装置大,而叶片式清洗设备的优点是粒子性能比总线式好,由于将通过过滤器预先除去液体中存在的粒子的药液·纯水施加到晶圆上,因此液体不会将过滤器直径以上的粒子附着到晶圆表面。其优点是药液·纯水消耗量比汇流式装置小;通常,每片晶圆使用纯水约为每分钟1升,劣势在于,与总线式清洗设备相比,晶圆生产率较小。因此,为了补充生产率,有时每个清洗装置设置10个左右的处理室,
这样,由于总线式清洗装置和单叶式清洗装置具有特点,制造半导体器件的各公司根据制造的半导体器件是哪种配线尺寸代(节点代)的产品,以及清洗目的和工艺,分别使用采用的器件类型
下面介绍晶圆表面的清洁度,清洗晶圆后,确认清洗性能的方法,首先,粒子当然是目视无法看到的小粒子,因此通常使用被称为激光式粒子检查装置的检查仪器,将氩等激光器扫描到晶圆表面,当存在粒子时,通过检测与粒子尺寸相关的散射激光量,将晶圆表面上的粒子位置和尺寸显示为晶圆图,现在,作为市场上销售的检查装置,可以检测到的最小粒子尺寸约为30 纳米左右。
接下来,对金属成分的测量方法进行阐述,在20多年前,主要采用寿命测量方法,这种方法是利用预先测量寿命和金属杂质量的数据作为标准,通过测量晶圆寿命的值,类推金属杂质的附着量,最近,许多半导体制造公司正在采用测量实际附着金属成分量的分析方法,而不是使用寿命时间方法,即ICP-MS(电感耦合等离子体质谱仪)TXRF(全反射荧光X射线反射)。
最后是有机物测量,GC/MS方法被普遍使用,在尖端半导体器件制造中,来自洁净室内存在的装置、构件、药液等构成物质的微量有机物气体,在制造过程中引起反应物的形成和异常生长,从而降低半导体器件的成品率。
对晶圆的湿法蚀刻法、清洗和清洁度进行了简单的描述,在半导体器件制造中,从创建期到现在,与粒子等杂质的斗争在将来也不会改变,在与粒子的战斗中最重要的工序是清洗,可以想象今后也会越来越受到重视,如果清洁技术不能日新月异地进步,那么总有一天,半导体器件会受到良率低下而无法制造的致命伤害。