
扫码添加微信,获取更多半导体相关资料
宽带隙半导体具有许多特性,这些特性使其对高功率、高温器件应用具有吸引力。本文综述了三种重要材料的湿法腐蚀,即ZnO、GaN和SiC。虽然ZnO在包括HNO3/HCl和HF/HNO3的许多酸性溶液中以及在非酸性乙酰丙酮中容易被蚀刻,但是III族氮化物和SiC非常难以湿法蚀刻,并且通常使用干法蚀刻。已经研究了用于GaN和SiC的各种蚀刻剂,包括含水无机酸和碱溶液,以及熔融盐。湿法蚀刻对宽带隙半导体技术具有多种应用,包括缺陷装饰、通过产生特征凹坑或小丘来识别极性和多型体(对于SiC ),以及在光滑表面上制造器件。对于GaN和SiC,电化学蚀刻在室温下在某些情况下是成功的。此外,光辅助湿法蚀刻产生类似的速率,与晶体极性无关。
介绍
宽带隙半导体GaN、SiC和ZnO对于许多新兴应用是有吸引力的。例如,AlGaN/GaN高电子迁移率晶体管(HEMTs)和单片微波集成电路(MMICs)的发展保证了高频操作。此外,GaN用于紫外波长光电器件。它具有高击穿电场,大于硅或GaAs的50倍,这允许它用于高功率电子应用。GaN的宽带隙允许其用于蓝色/紫外线发光二极管(led)和激光二极管(LD ),并且由于其低本征载流子浓度,允许其在非常高的温度下工作。高电子迁移率和饱和速度允许其用于高速电子学。此外,诸如AlGaN/GaN的异质结构允许制造诸如HEMTs的高速器件。ZnO是一种具有纤锌矿晶体结构的直接宽带隙材料,可用于气体传感器、透明电极、液晶显示器、太阳能电池、压电换能器、光电子材料器件、蓝光、紫外光发光二极管和激光二极管。ZnO对蓝光/紫外发光二极管和薄膜晶体管(tft)有很大的兴趣。与GaN相比,ZnO具有在廉价玻璃上相对低的生长温度和比GaN (25meV)高得多的激子结合能(约60meV)的优势。这意味着ZnO在室温下具有更稳定的激子态,因为热能约为26meV。ZnO半导体中的激子不会由于室温下的热或激子之间的散射而离解成自由电子或空穴。此外,商业ZnO衬底是可用的。相对于不能在安全温度下在常规酸混合物中湿法蚀刻的GaN,ZnO系统还具有更简单的处理。SiC是用于高温、高功率和高频电子器件的另一种有吸引力的半导体,这是由于它的宽带隙(6H的3.08 eV和4H的3.28 eV)、高的击穿电场和高电子饱和速度。所有化合物半导体器件和电路占据微电子市场的总百分比约为5%,但它们确实填补了硅无法填补的重要空白。
当处理化合物半导体时,存在许多挑战,包括与III族和II族元素相比,V族和VI族元素相对高的蒸气压,以及形成高度可靠的欧姆和整流接触的困难。有必要为异质结构系统中的不同材料开发高选择性以及非选择性的蚀刻工艺。InGaN/GaN/AlGaN)和ZnO(即ZnMgO/ZnO/ZnCdO)。许多努力致力于获得晶格匹配的组合物,以避免引入螺旋位错,螺旋位错会降低随后制造的器件的电传输和光学质量。在某种程度上,InGaN/AlGaN系统是一个例外,因为已经展示了高亮度发光二极管(led)和激光二极管。对于led,由此产生的可靠性足以满足商业应用,但异质外延材料中的高位错密度会限制激光二极管的寿命,因为高得多的电流密度会导致金属迁移,使pn结短路。在准GaN衬底上生长的材料中,不存在这种机制,并且激光二极管具有更长的寿命。
湿法腐蚀
通常,III-V族材料的湿法蚀刻包括使用氧化剂来氧化表面,随后溶解可溶性反应产物。所得蚀刻倾向于本质上基本各向同性,如图1的示意图所示进行。这说明了从层2到层1的选择性蚀刻,以及层1上掩模的底切。在III-V族化合物的情况下,主要包含一种或另一种元素的结晶方向的不同蚀刻速率会导致一定程度的各向异性和不同的侧壁形状。
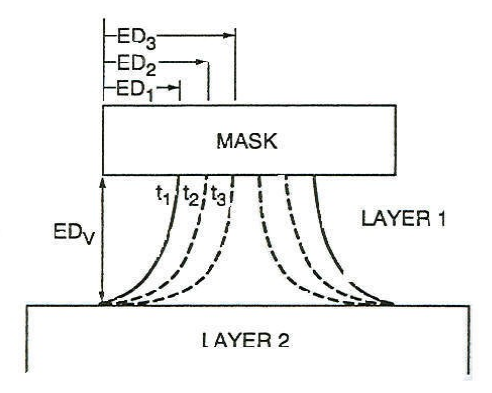
图一 从一层到另一层的选择性湿法蚀刻示意图
蚀刻速率可能受到活性蚀刻剂物种向半导体表面扩散的限制,或者受到可溶性产物扩散离开的限制。在这种情况下,蚀刻被称为扩散限制,其特征包括蚀刻深度对蚀刻时间的平方根依赖性、活化能£6·千卡·摩尔-1和蚀刻速率对溶液搅拌的强烈依赖性。这种蚀刻模式对于器件制造来说是不理想的,因为难以获得可再现的速率。
另一个限速步骤可能是地表的化学反应。在这种情况下,蚀刻深度线性依赖于时间,活化能为³6·千卡·摩尔-1,速率与溶液搅拌无关。这是器件制造的优选蚀刻模式,因为只需要控制温度和溶液组成。
由于湿法蚀刻在本质上趋向于各向同性,掩模的底切使其不适于小(< 2 mm)特征的图案转移。相对于干法蚀刻还有许多其他缺点,包括由于潜在暴露于化学物质和烟雾而增加的安全风险,以及在蚀刻过程中可能导致局部未蚀刻区域的气泡形成。
由于其硬度(H=9+),SiC是用于金属、金属部件和半导体晶片的最广泛使用的研磨和抛光磨料之一。然而,正是这种性质使其难以在典型的酸或碱溶液中蚀刻。在其单晶形式中,SiC在室温下不会受到单一酸的侵蚀。事实上,蚀刻SiC的唯一技术采用熔融盐熔剂、热气、电化学过程或等离子体蚀刻。表1列出了成功蚀刻SiC所需的熔融盐溶液和温度。这些高温、腐蚀性混合物的缺点包括需要昂贵的铂烧杯和样品架(可以承受熔融盐溶液),以及不能蚀刻被掩蔽的样品,因为很少有掩模能承受这些混合物。虽然可以设想使用Pt掩模,但是湿法蚀刻是各向同性的,因此会底切掩模。
光电化学蚀刻可以成功地用于SiC 。通过用高于带隙的光照射,半导体在酸或碱溶液中的溶解速率可以改变。光增强蚀刻的机理包括产生e-h对,随后将半导体氧化分解成其组成元素(消耗光生空穴的反应),以及通过与光生电子反应还原溶液中的氧化剂。通常,n型材料在这些条件下容易被蚀刻,而p型材料则不是因为需要在半导体-电解质界面限制光生空穴(即,p型表面由于能带弯曲而耗尽空穴)。这允许从下面的p-SiC层(20)选择性去除n-SiC。在没有照明的条件下,如果样品被正确偏置,通常有可能获得相反的选择性,因为n-SiC需要光生载流子来进行蚀刻。使用汞灯可以实现大面积的蚀刻,并且由于金属掩模(通常为Ti)的遮蔽效应,使得载流子仅在未被掩蔽的区域中产生,所以获得了一定程度的各向异性。该技术的一些缺点包括相当粗糙的表面形态(由于晶体缺陷周围区域的溶解速率提高),不能图案化非常小尺寸的特征以及蚀刻速率的不均匀性。由于这些原因,现在大部分注意力集中在SiC的干法蚀刻方法上其已经被开发用于该材料系统中的高功率、高温电子设备。
氮化物
在开发III-V族氮化物的湿法蚀刻溶液方面取得的成功相对较少。对于AlN,已经报道了非晶或多晶材料的多种不同解决方案。例如,已经发现热(£85oC) H3PO4以低速率蚀刻通过等离子体增强化学气相沉积在Si上沉积的AlN(£500 å×min-1).各种其他溶液,包括热(~ 100摄氏度)HF/H2O、HF/HNO3或NaOH(29)可以蚀刻溅射或反应蒸发的无定形AlN。对于GaN,有几个早期的在NaOH中湿法蚀刻的报道,其通过形成不溶性氢氧化镓(GaOH)涂层而进展。这种薄膜必须通过连续的喷射动作来去除。其他人已经报道H3PO4将以非常慢的速率去除GaN。对于InN,发现KOH和NaOH水溶液在60℃下产生几百埃/分钟的蚀刻速率。在寻找用于单晶氮化物的可靠湿法蚀刻剂方面存在特别的困难。
在低于80℃的温度下,我们没有发现对GaN或InN的任何蚀刻剂。然而,发现强碱溶液(KOH、NaOH或光致抗蚀剂显影剂,其中活性成分是KOH)以可控速率蚀刻单晶AlN,其程度强烈依赖于材料质量。
图2显示了三种不同AlN样品在AZ400K光致抗蚀剂显影剂中的蚀刻速率与温度的关系图。
1.由三角形表示的数据来自在GaAs上生长的多晶AlN。这种材料的蚀刻速率比生长在Al2O3上的两个单晶样品快得多。
2.用正方形表示的数据来自双晶x射线衍射峰宽为4000弧秒的1mm厚层。
3.圆圈表示的数据来自峰宽约200弧秒的材料。

图2 不同AlN样品在KOH基溶液中的蚀刻温度,作为温度的函数
在每种情况下,蚀刻是用大约15.5千卡/摩尔的活化能热活化的。这与反应限制蚀刻一致,并且还发现蚀刻深度是时间的线性函数,不依赖于搅拌。如果蚀刻是受扩散限制的,我们预计活化能低于6千卡/摩尔蚀刻对时间的Öt依赖性,以及蚀刻速率对溶液搅动程度的强烈依赖性。在溶液中被OH-离子攻击的悬挂键或缺陷键的数量较多的基础上,预计结晶质量较低的材料的比率较高。因此,在这些条件下,成功尝试的频率更高,蚀刻速率R更高。这个过程可以用下面的关系式很好地描述。
其中Ro是断裂Al-N键和形成可溶性蚀刻产物的成功尝试频率,Ea是活化能(15.5千卡/摩尔),k是玻尔兹曼常数,T是蚀刻溶液的绝对温度。
我们已经观察到退火对溅射AlN膜在KOH溶液中的后续湿蚀刻速率有强烈的影响,在1100℃退火后速率降低了一个数量级以上。类似地,生长在Si上的In0.2Al0.8N在基于KOH的溶液中的蚀刻速率比生长在GaAs上的材料的蚀刻速率大约高三倍,这与后者的优异结晶质量一致。InxAl1-xN的蚀刻也作为In组分的函数进行检测,蚀刻速率最初在In中增加到36%,然后对于InN降低到零。
其他研究人员发现,只有熔融盐(KOH、NaOH、P2O5)才能在高于300摄氏度的温度下蚀刻GaN,这使得处理和掩蔽材料变得不切实际。
在以往的研究使用稀HCl/H2O或45% KOH/H2O的GaN的激光增强室温湿法蚀刻,其中HCl的速率高达几千埃/分钟,KOH的速率高达几千埃/分钟。该机制被认为是在相当于电化学电池中氧化和还原反应的光增强。蚀刻速率线性依赖于入射HeCd激光功率。Zory等人(38)已经采用了一种结合了40份乙二醇、20份水和1份85% H3PO4的脉冲电化学电池,以高达1.5 mm/h.的速率蚀刻p-GaN和InGaN外延层。电池电压(220 V)以100 Hz (300 mm/sec脉冲宽度)脉冲。这种技术被用于制造双异质结构p-10采用液体接触的GaN/InGaN QW/n-GaN发光二极管。
总之,ZnCdO、ZnMgO和ZnO可以容易地在HCl和H3PO4的稀溶液中蚀刻。这些酸与水的高稀释系数为ZnCdO提供了30–90nm min-1范围内的可控蚀刻速率,为ZnMgO提供了120–1100nm min-1范围内的可控蚀刻速率,并对相同条件下生长的ZnO具有足够的选择性。光致抗蚀剂为在这些酸溶液中构图ZnCdO、ZnMgO和ZnO提供了稳定和方便的掩模。这种异质结构系统的简单湿溶液的可用性简化了台面型ZnO基led的加工,并且避免了对等离子体蚀刻工艺的需要,已知等离子体蚀刻工艺即使在低等离子体功率下也会损坏ZnO表面。
结论
GaN和SiC的湿法蚀刻对于大多数器件应用来说是困难的和不切实际的。在这些情况下,干法蚀刻是优选的。ZnO在大多数酸溶液中容易蚀刻,而干法蚀刻相对困难。