
扫码添加微信,获取更多半导体相关资料
在本研究中,我们研究了在液晶显示(LCD)技术中常用的蚀刻剂中相同的ITO薄膜的蚀刻速率,保持浴液温度恒定,并比较了含有相同浓度的酸的溶液,对ITO在最有趣的解决方案中的行为进行了更详细的研究,试图阐明这些浴液中的溶解机制。
ITO通过每分钟5.5标准立方厘米的氧流量的直流磁控溅射均匀沉积在玻璃基底上,目标的密度为70%,衬底温度为350°C,沉积电压和功率设置分别为375V和1.7kW,得到的ITO层厚度为120纳米,在550纳米处超过85%的透射率,ITO膜的化学组成通过以下方式获得俄歇电子能谱,都在表面和整体。
蚀刻实验是用部分被光刻胶覆盖的ITO样品进行的,样品垂直放置在蚀刻剂中,蚀刻后,样品在去离子水中冲洗,抗蚀剂在丙酮中剥离,样品在氮气流中干燥,测量蚀刻深度,对于每个蚀刻率测定,这至少5次不同的蚀刻时间,蚀刻深度作为时间的函数绘制,蚀刻率以直线的斜率得到,实验在30或50°C条件下进行,温度保持在0.1°C范围内,电化学测量是在室温下进行的标准电化学电池中包含ITO样品,一个大面积铂对流电极和一个饱和热量参比电极(SCE),使用温金恒电位器LB75L,结合高温度仪器小波发生器PPRI和飞利浦X-Y记录器PM8143,在100mV/s的扫描速率下记录伏安图。
在室温下在电化学电池中进行电位蚀刻实验,在这些实验中,仅测量了一次蚀刻时间后的深度作为应用电位的函数,所有溶液均用去离子水和试剂级化学品制备,为了研究酸的种类是否对ITO的蚀刻动力学有影响,我们在50°C下用不同的蚀刻剂进行了实验。
所有检测的溶液都显示了ITO的一定的攻击,醋酸(乙酸)、磷酸、草酸(草酸)和硫酸的检出率极低(<<为1纳米/分钟),虽然硝酸的比率要高得多,但在设备技术的实际应用中仍然太低。大多数氧化物的溶解明显受到H-+离子浓度的影响。
氧化剂对酸中氧化物蚀刻速率的影响,添加的氧化还原偶联的氧化电位值对溶解动力学有明显的影响,添加的氧化还原偶联的氧化电位值对溶解动力学有明显的影响,对这种效应的解释并不简单,因为参数如pH、金属离子的络合、氧化物中的缺氧和电位同时工作。由于在这种情况下,ITO是缺氧的,因此蚀刻率增加的最合理的原因是金属离子被氧化成更高的价,这就意味着,这种氧化作用随后就会被氧化剂的还原作用所抵消,然后在溶液中加入氧化剂就会导致静止电位的阳极位移。
对ITO在6MHCI和6MHCI+0.2MFeCI3中蚀刻过程中的剩余电位进行了测量,得到的值似乎表明,动力学的增强是由更多的阳极电位引起的,而ITO的电化学氧化应该是可能的,除了双层电荷外,没有其他电流。当TM将扫描范围扩展到更多的阴极电位时,得到了如图1所示的曲线。
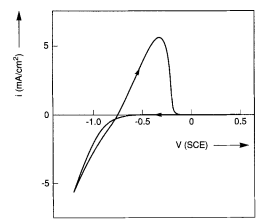
这是由于ITO表面的还原,在随后的阳极扫描中得到了一个氧化峰,被还原的物种在这次扫描中被重新氧化,只有当电极的阴极电极值大于-0.5V(SCE)时,才能观察到氧化电流。这甚至也适用于浓缩的HC1溶液,这些实验表明,ITO是电化学惰性的。
通过静电位蚀刻实验,研究了应用电位是否会影响化学蚀刻速率,这些实验的结果如图2所示。在电位低于-0.50V(SCE)时,蚀刻率增加,结果显示出很大的散点,这是由于还原过程导致表面出现颗粒,用谷物上或旁边的Alpha步长测量,结果产生很大的差异,在碱性溶液中也可以观察到同样的效果,虽然添加氧化剂可以增加蚀刻速率,但伏安图和静电位蚀刻实验都表明,这不是由于观察到的静止电位的阳极位移,这显然不是一种电化学效应,这种效应的真正来源尚不清楚,是进一步研究的重点。

另外在浓度对蚀刻速率的影响的实验中, HC1和氢溴酸之间没有发现差异,在低浓度(<2M)时,蚀刻速率可以忽略不计。在约2M时,速率可以测量,并随着浓度的增加而急剧增加,这种行为类似于未解离的酸在水溶液中的活性。在低浓度时,水中的解离是完全的,但在较高浓度时,未解离酸的数量增加。解离受到溶剂介电常数e的强烈影响。虽然用e较低的溶剂稀释HC1浓缩(12M)水溶液仍含有一定量的水,但解离率明显低于水稀释后。
ITO在卤素酸中的行为与InP非常相似,因此似乎合理的假设是认为同样的机制是有效的。In-O键的断裂将比完全离子固体的溶解更困难,在20-50~之间的动力学实验得到了活化能为-70kJ/mol。这个高值可以用所提出的键断裂序列来解释,反应方案也表明,蚀刻不应受到溶液中的质量输运的影响,我们用旋转的ITO样品进行了实验,确实发现对溶解速率没有任何影响。
由In2OJSnO2靶直流磁控溅射制备的玻璃ITO薄膜,卤素和其他酸的蚀刻动力学存在较大差异,卤素酸的蚀刻速率在一个技术上有趣的范围内,而其他酸的蚀刻速率极低,溶解反应与未解离的卤素酸分子一起进行,这一过程在本质上是纯化学的,不受阳极势的影响,观察到的结果可以用In-O键和H-X键同时断裂以及In-X键和H-O键同时形成的模型来解释,在HC1溶液中加入Is显著提高了ITO的蚀刻率,结果表明,这是一种非电化学效应。