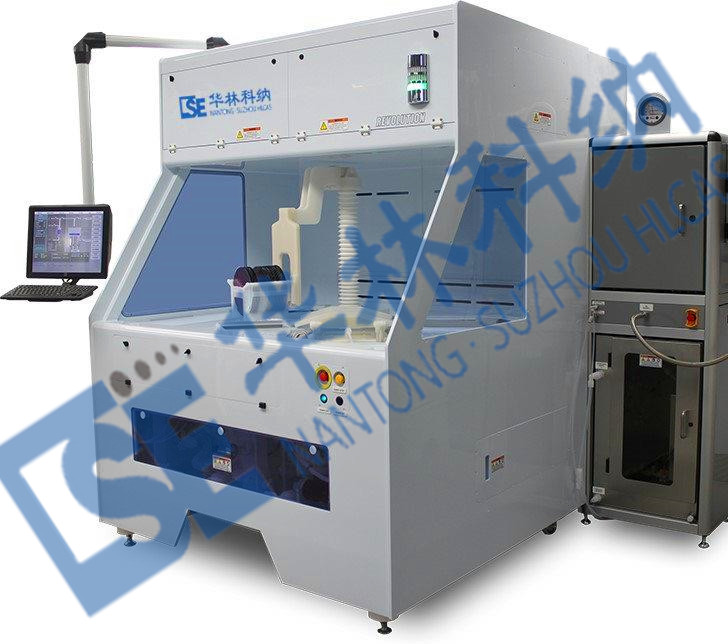
刻蚀方法分为:干法刻蚀和湿法刻蚀,干法刻蚀是以等离子体进行薄膜刻蚀的技术,一般是借助等离子体中产生的粒子轰击刻蚀区,它是各向异性的刻蚀技术,即在被刻蚀的区域内,各个方向上的刻蚀速度不同,通常Si3N4、多晶硅、金属以及合金材料采用干法刻蚀技术;湿法刻蚀是将被刻蚀材料浸泡在腐蚀液内进行腐蚀的技术,这是各向同性的刻蚀方法,利用化学反应过程去除待刻蚀区域的薄膜材料,通常SiO2采用湿法刻蚀技术,有时金属铝也采用湿法刻蚀技术。
下面分别介绍各种薄膜的腐蚀方法流程:
二氧化硅腐蚀:
在二氧化硅硅片腐蚀机中进行,腐蚀液是由HF、NH4F、与H2O按一定比例配成的缓冲溶液。腐蚀温度一定时,腐蚀速率取决于腐蚀液的配比和SiO2掺杂情况。掺磷浓度越高,腐蚀越快,掺硼则相反。SiO2腐蚀速率对温度最敏感,温度越高,腐蚀越快。
具体步骤为:
1、将装有待腐蚀硅片的片架放入浸润剂(FUJI FILM DRIWEL)中浸泡10—15S,上下晃动,浸润剂(FUJI FILM DRIWEL)的作用是减小硅片的表面张力,使得腐蚀液更容易和二氧化硅层接触,从而达到充分腐蚀;
2、将片架放入装有二氧化硅腐蚀液(氟化铵溶液)的槽中浸泡,上下晃动片架使得二氧化硅腐蚀更充分,腐蚀时间可以调整,直到二氧化硅腐蚀干净为止;
3、冲纯水;
4、甩干。
二氧化硅腐蚀机理为:
SiO2+4HF=SiF4+2H2O
SiF4+2HF=H2SiF6
H2SiF6(六氟硅酸)是可溶于水的络合物,利用这个性质可以很容易通过光刻工艺实现选择性腐蚀二氧化硅。为了获得稳定的腐蚀速率,腐蚀二氧化硅的腐蚀液一般用HF、NH4F与纯水按一定比例配成缓冲液。
由于基区的氧化层较发射区的厚,以前小功率三极管的三次光刻(引线孔光刻)一般基极光刻和发射极光刻分步光刻,现在大部分都改为一步光刻,只有少部分品种还分步光刻,比如2XN003,2XN004,2XN013,2XP013等。但是由于基区的氧化层一般比发射区的厚,所以刻蚀时容易发生氧化区的侵蚀。
二氧化硅腐蚀后检查:
1、窗口内无残留SiO2(去胶重新光刻);
2、窗口内无氧化物小岛(去胶重新光刻);
3、窗口边缘无过腐蚀(去胶重新光刻);
4、窗口内无染色现象(报废);
5、氧化膜无腐蚀针孔(去胶重新光刻);
6、氧化膜无划伤等(去胶重新光刻)。
Al上CVD腐蚀:
掺磷的SiO2是磷硅玻璃,如果PSG是长在铝上做钝化层,这时采用二氧化硅腐蚀液腐蚀会伤及铝层,所以一般采用如下腐蚀液:冰乙酸:氟化铵=2:3。具体步骤为:
1、将装有待腐蚀硅片的片架放入浸润剂(FUJI FILM DRIWEL)中浸泡10—15S;
2、将片架放入装有腐蚀液(冰乙酸:氟化铵=2:3)的槽中浸泡,并且上下晃动片架;
3、将片架放入装有甲醇溶液(甲醇:纯水=1:1)的槽中浸泡;
4、在溢流槽中溢流冲水;
5、冲纯水;
6、甩干。
铝腐蚀:
在铝腐蚀清洗机中进行,具体步骤为:
1、将装有待铝腐蚀硅片的片架放入浸润剂(FUJI FILM DRIWEL)中浸泡10-15s,并且上下晃动;
2、将片架放入装有45℃左右的铝腐蚀液(磷酸+硝酸+醋酸+纯水)的槽中浸泡,上下晃动片架,使得铝腐蚀更充分,腐蚀的时间根据先行片的腐蚀时间进行调整,直到腐蚀后看到二氧化硅表面为止;
3、冲纯水;
4、甩干:在甩干机中甩干后烘干。
磷酸约占80%,主要起腐蚀铝的作用,硝酸占1%-5%,其与铝反应生成溶于水的硝酸盐,可以提高腐蚀速率,但含量过多会影响光刻胶抗蚀刻能力,醋酸占10%左右,它能降低腐蚀液的表面张力,增加硅片与腐蚀液的浸润效果,提高腐蚀均匀性,同时具有缓冲作用,纯水占5%左右。
铝腐蚀后检验,主要项目有:
1、连铝、铝过腐蚀、铝条间残铝、铝条不过细、铝条氧化——去胶后重新蒸铝;
2、铝条变色(灰、黑、黄)——如果变色严重则报废。
SIPOS腐蚀:
1、将装有待腐蚀硅片的片架放入浸润剂(FUJI FILM DRIWEL)中浸泡20—30S,上下晃动;
2、将片架放入装有腐蚀液(40%NH4F溶液:H2O:40%HF溶液=10:6:1)的槽中浸泡,并且上下晃动片架;
3、冲纯水;
4、甩干。
等离子体刻蚀:
等离子体刻蚀可用于刻蚀SiO2,Si3N4,多晶硅等,但是,通常氧化硅用湿法腐蚀快,而氮化硅也可以采用二氧化硅腐蚀液,但是腐蚀速度慢,因此氮化硅刻蚀用干法刻蚀,所用的设备有901E/903E TEGAL plasma etching system型等离子刻蚀设备,用的的刻蚀气体有:CF4、O2、N2、SF6、CHF3、NF3、He、C2F6等。
1)Si3N4刻蚀:
在903E刻蚀机中刻蚀,刻蚀机内通入的气体有:CF4、NF3、He。
刻蚀机理是: CF4电离→CF3+F*(氟自由基)
CF3电离→CF2+F*
CF2电离→CF1+F*
12F*+ Si3N4→3Si F4↑+2 N2↑
氟游离基的作用是使氮化硅被腐蚀,生成物是气体,被真空装置抽气抽走。为了加快腐蚀速率可以在CF4中加入少量氧气(5%-8%),因为氧能够抑制F*在反应腔壁的损失,并且:CF4+O2→F* +O*+COF*+COF2+CO+…… (电离)
COF*寿命较长,当它运动到硅片表面时发生以下反应从而加速了腐蚀速率:
COF*→F* CO (电离)
但是氧气加多了要腐蚀光刻胶降低选择比。
2)SIPOS、多晶硅刻蚀:
在901E刻蚀机中刻蚀,刻蚀机内通入的气体有:SF6。
玻璃腐蚀:
1、 配制5%HF溶液,
配制腐蚀液:5%HF溶液:H2O=3:50;
2、常温下,将硅片放入腐蚀液中浸泡;
3、在溢流槽中冲洗;
4、冲纯水;
5、甩干。
湿法去胶:
铝淀积前去胶在SH去胶机(湿法腐蚀机)中进行,采用SH溶液将胶氧化的方法去胶,具体步骤为:
1、在SH清洗剂(98%H2SO4:H2O2=3:1)中浸泡;
2、在温纯水中溢流冲水;
3、在溢流槽中溢流冲水;
4、甩干。
由于酸对铝有腐蚀作用,淀积铝后去胶就不能用酸,在此采用有机溶剂OMR502剥离液去胶,在OMR剥离清洗机中进行,具体步骤为:
1、在剥离液(OMR-83剥离液)中浸泡去除光刻胶;
2、再在H-1清洗剂中浸泡去除剥离液;
3、在异丙醇中浸泡去除H-1清洗剂;
4、冲纯水;
5、甩干。
等离子体干法去胶:
用HDK-2型等离子刻蚀去胶机去胶,在去胶机内通入刻蚀气体O2。等离子体内的活化氧使有机物在(50—100)℃下很快氧化,生成CO2、CO、H2O等挥发性成份,从而达到去胶目的。
特殊胶(PI钝化产品、带胶注入产品):PI去胶时除了O2,再加适量的CF4,如果去不干净再在等离子刻蚀机上用SF6处理。
一般在Si3N4刻蚀后去胶用有机溶剂剥除,然后在等离子体去胶机中去胶丝,刻蚀后在显微镜下观察硅片表面是否有残丝。
去胶后检查:
1、有残胶——再去胶;
2、有残液——再清洗;
3、有残迹——用1号液清洗;
4、窗口有二氧化硅或铝残留。
更多的半导体湿法腐蚀刻蚀清洗设备相关资讯可以关注华林科纳CSE官网(www.hlkncas.com),现在热线咨询400-8798-096可立即获取免费的半导体清洗解决方案。