光罩清洗的流程以及优化
摘 要:光罩清洗的流程以及优化,需要在实际生产运用中来完善,要保证在不影响清洗能力的情况下来优化各个工艺参数,在各种工艺清洗时的时间和MASKStage的转速来缩短清洗光罩的时间,而这个参数需要在不断地实验中完善。该文针对目前液晶面板在正常生产的过程中光罩(MASK)日常清洗的流程及工艺,介绍了目前光罩清洗机中使用的几种主要的清洗工艺,清洗光罩时需根据不同原因来选择所需要的工艺来清洗,以及对清洗工艺的优化。
关键词:光罩光罩清洗机曝光机
1清洗MASK的类别
1.1拆包清洗
在首次光罩到厂后进行,要将光罩从光罩盒中取出,并进行检查确认,若检查没有问题再使用正常的清洗工艺清洗,清洗后放置于MASKStocker内,以备使用。
1.2日常清洗
在产线切换产品或者连续生产达到一定数量时,为了防止光罩被污染而产生MASK共通缺陷,需要对光罩进行清洗。主要是因为液晶生产中所使用的光阻特性,有的光阻比较容易挥发产生升华物滴落在基板的表面,在基板进入曝光机曝光时由于曝光的GAP较小,从而部分升华物会接触到光罩表面,产生MASK共通缺陷,而使生产出的产品在相同的位置有着同样的不良缺陷。
1.3出现MASK共通时清洗
特别是接近式曝光机,曝光时光罩与玻璃基板的GAP较小,曝光时的GAP可能只有100~200μm(如图1所示)。如果基板上有光阻或其他异物,有可能在曝光时将异物粘到光罩上或者异物有可能会刮伤光罩,从而导致生产的产品在每个panel的相同位置产生同样的缺陷;洁净房的洁净度和人员出入设备也有可能会引起发尘而污染光罩。
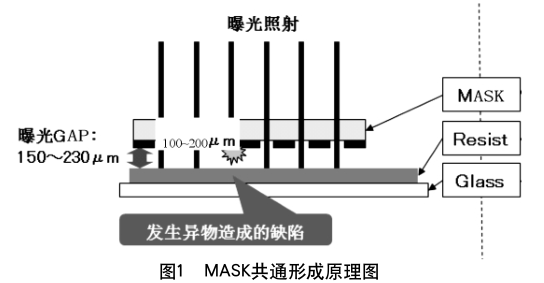
2MASK清洗的流程
在从曝光机卸载下MASK之后,通过MASK台车送至光罩清洗室准备进行清洗。首先需要确认光罩清洗机的工作状态,确认药剂Tank的温度以及药剂是否足够等,然后再将MASKCASE从台车送入光罩清洗机,选择适当的清洗工艺进行清洗作业。光罩在光罩清洗机内清洗主要流程:正面清洗、背面清洗(膜面)以及检查3个步骤,可以根据清洗的不同原因通过工艺编辑更改清洗的顺序。
光罩的正面和背面清洗主要包括纯水冲洗、毛刷和洗剂清洗、毛刷和纯水清洗、超声波清洗以及氮气干燥这几个步骤,每个步骤MASKStage都会按照设定的转速旋转(如图2所示)。而且为了防止在清洗时,正面洗过的液体流向背面,在清洗时所有步骤都会使用位于MASKStage下方的喷淋口,使用纯水对光罩的下面进行纯水的喷淋作业。
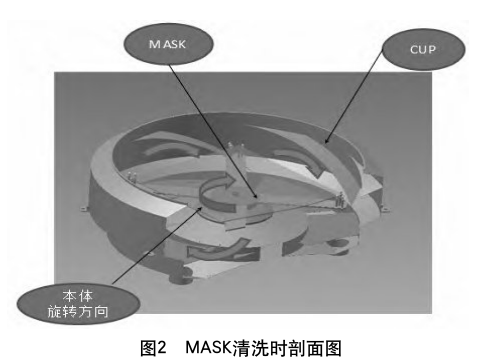
3MASK清洗的工艺
光罩在光罩清洗机内清洗时,主要流程是纯水冲洗、毛刷和洗剂清洗、毛刷和纯水清洗、超声波清洗以及氮气干燥,在这清洗的每道工序进行的时候,MASKStage都会按照设定的转速一直旋转,以达到可以整面清洗的目的,下
面分别介绍主要清洗的工艺。
3.1毛刷清洗(纯水、药液)
MASK在光罩清洗机内清洗时,主要是依靠毛刷进行清洁光罩表面的脏污。毛刷需要采用吸水性、恢复性、耐磨性、耐腐蚀性等方面都较出色的材料制成的盘刷,在毛刷回转速时,毛刷外周的接触面积较大,可以有效提高清洗效果。在清洗光罩时,可以通过设定毛刷的转速以及毛刷的压入量来改善清洗效果。
3.2超声波清洗(MS清洗)
正常清洗时,毛刷配合药液清洗之后会使用超声波和纯水共同清洗来去除微细颗粒。超声波Shower通过设定输出功率来变更清洗能力。在MS清洗模块固定不动的情况下,有效的清洗面积比较小,但通过MASKStage的自旋转,以及MS清洗模块的来回移动可以将光罩的整面都覆盖。
3.3氮气(N2)干燥
在光罩清洗结束之后,MASKStage会慢慢加速旋转,当达到一定速度时会保持一个恒定的转速,同时,氮气干燥管会慢慢移动到光罩中心位置正上方,与光罩下方的氮气气管同时向光罩吹气,通过离心力的作用,将光罩表面的液体吹出表面以达到干燥效果。
4MASK清洗的流程优化
在初次清洗光罩建立清洗工艺的时候,清洗光罩顺序的选择:先清洗光罩的反面再清洗光罩的正面,清洗完毕后进行检查确认;但在实际生产过程中发现这样的清洗步骤会多一次光罩翻转,而光罩翻转是不必要的时间,所以清洗光罩时将清洗光罩的顺序变更为先清洗光罩的正面再清洗光罩的反面,可以节约一次翻转光罩的时间。
正常清洗时,还可以通过提高毛刷的转速和毛刷的压入量、MASKStage的转速来达到提高清洗效果的目的。光罩污染主要是针对与生产基板接近的膜面(光罩的反面),所以,在清洗光罩时使用的清洗工艺可以大大减少对于光罩正面的清洗时间而稍微增加光罩(光罩的反面)膜面的清洗时间。
5结语
当然,采用接近式曝光机,产生MASK共通的几率要远远大于扫描式曝光机,而曝光机整体的洁净度更是可以影响清洗光罩的频度,所以液晶生产中清洗光罩的时间,不仅仅要对清洗的工艺进行优化,也要对洁净室的环境进行定期检测,以保证洁净度可以达到相应的要求。(免责声明:文章来源于网络,如有侵权请联系作者删除。)