
扫码添加微信,获取更多半导体相关资料
引言
以DRAM及CPU为代表的超大规模集成电路硅半导体器件,近年来成为个人电脑热潮的导火索,预计今后器件的需求也会扩大。 那么,该硅半导体器件的基板材料几乎都是通过直拉法(CZ)法培育的单晶硅。 通过对单晶硅锭进行切割、研磨、蚀刻、镜面抛光以及湿法清洗工序,制作出厚度为700-800μm的镜面晶圆。 随着半导体器件的微细化及高性能化,晶圆表面的高品质化被进一步要求。晶圆表面质量有粒子、金属杂质、有机物、微粗糙度及自然氧化膜。在本文中,在CZ法硅镜面晶圆的加工中,关注表面的粒子及各种污染,对除去这些粒子的湿法清洗工序的概要及相关技术进行了叙述。
硅片清洗技术
我们已知清洗对镜面抛光后的晶圆表面质量有很大的影响,随着超大规模集成电路器件的微细化及高性能化的发展,人们逐渐认识到清洗的重要性,近十年来,研究也开始盛行起来。目前的镜面抛光晶圆的清洗大部分采用RCA法或其改良法。RCA法的基础是NH、OH/H202/H、O(称为SC-1清洗)以及HCI/H、O、/H、0(称为SC-2清洗),分别具有去除颗粒和金属污染的效果。 在实际的清洗技术中,根据用途组合这些,有效地去除粒子、金属杂质以及有机物。 下面就粒子、金属杂质以及干燥技术进行说明。
如图1所示,由于256MDRAM以后的世代采用了0.25μm的设计规则,因此在这些器件中使用的φ300mm晶片上,预计尺寸0.1μm级的粒子会对器件特性产生影响。下面,将对通过清洗除去粒子的机理、以及晶圆表面粒子的测量原理及问题点进行叙述。一般来说,在去除硅晶圆表面的粒子时,碱性的清洗比酸性的清洗更有利。对去除粒子有效的SC―1清洗是同时发生NH40H对硅的蚀刻和H202对硅的氧化的反应体系。据推测,去除颗粒的主要原因是NH40H的蚀刻。此外,我们还提出了基于溶液中的晶圆及粒子的zeta电位的粒子附着模型。在SC―1清洗中,NH40H蒸发显著,从除去粒子的观点来看,药液的使用时间受到限制。因此,为了在线监测药液中的浓度,使浓度恒定化,还提出了定量添加NH40H和H202的系统。在RCA清洗中,利用物理现象的超声波并用,有空化作用的类型(频率40~50kHz)或高频加速度的类型(频率900kHz~1MHz)。 前者对于去除尺寸较大的粒子是有效的,但担心会因空化而对晶圆造成损伤。另一方面,后者是利用巨大加速度或溶液的挤压效果,对去除小粒子有效。由于在该频率区域中不发生空化,因此晶片表面几乎没有损坏。
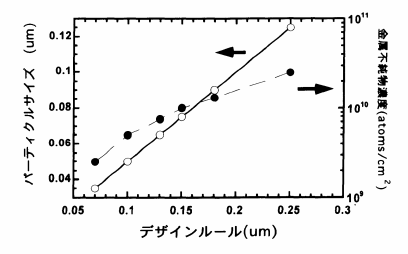
图1 导体器件的设计规则与晶圆表面特性的关系
在波形以及器件的制造过程中,存在来自工艺装置以及间材的金属污染(Al、Fe、Cu、Ni等)。需要开发去除这些金属杂质的清洗技术。 通常进行酸基SC-2洗涤或稀HF溶液与碱基SC-1洗涤的组合。SC-2清洗通过HCl的溶解作用和氯离子的配位结合力,对去除金属杂质有效果20>。 在图4中,将A1、Fe、Cu以及Ni强制污染了10′3atoms/cm2水平的晶圆,比较了稀HF和SC-2清洗后的金属污染水平,关于Cu,用稀HF清洗几乎无法除去,而用SC-2清洗则有很高的除去效果。 在SC―1清洗中,Al及Fe作为氧化物吸附在自然氧化膜上,离子化倾向比Si小的Cu直接吸附在Si上。 SC-1清洗容易去除硅表面的Cu和Ni。但是,如果清洗液中含有0.1 ppb左右的Fe、Al、Zn等金属杂质,晶圆表面就会附着浓度为1011atoms/cm2水平的污染,清洗液本身就会成为新的污染源。作为防止SC―1清洗时金属污染的方法,还提出了在清洗液中添加螯合剂的方法。
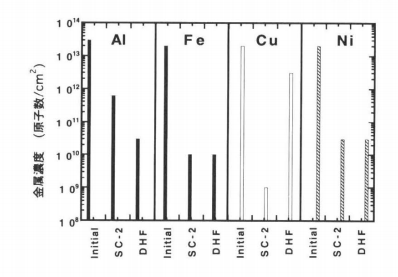
图4 以及稀HF清洗中的金属杂质去除效果
干燥技术:干燥与清洗工艺是一对重要的技术。关键是如何在减少水印(干燥痕迹)及颗粒的状态下,在短时间内进行干燥。在以往的旋转干燥及IPA蒸汽干燥中,在晶圆的大口径化时,图2粒子测量装置的光学系统模式图图3氢处理晶圆的LPD计数的变化粒子测量装置使用了图4 SC-2和稀HF清洗中的金属杂质去除效果。为了解决这些问题,为了降低粒子及水印,利用在稀IPA气氛中的室温水中拉起引起的表面张力差效果的干燥法受到关注。
最近的清洗技术
现在的硅晶圆的清洗装置,作为追求RCA清洗法的生产性的结果,大部分采用多槽分批浸渍处理方式。近年来,为了满足器件芯片尺寸的扩大、制造成本的增加,φ300mm晶圆的实用化正在取得进展。即使晶圆变成大口径,φ300mm晶圆的清洁度也会更加严格。在裸晶圆加工装置(研磨、研磨)的片叶化发展中,考虑晶圆批量生产线时,清洗装置的片叶化成为必不可少的技术之一。从晶片输送和工艺集成的观点来看,片材清洁比批量清洁更有利。常见的片叶式清洗装置示意图如图5所示。在旋转边缘保持在耐化学液体旋转杯中的晶片的同时,从各种喷嘴向晶片喷射化学液体或纯水。在以往的片叶式清洗装置中,具有耐化学性的超声波喷嘴以及旋转杯内的单元技术是最大的问题点,作为裸晶片的清洗,几乎没有实现φ200mm晶片的实用化。
近年来,开发出了图6所示的耐化学性的超声波MHz喷嘴。 通过ADDICPMS法25>·26)首次明确了从该喷嘴的金属污染溶出比以往的喷嘴少。 使用耐化学性及以往的喷嘴,向硅晶圆喷射浓度为30ppm的臭氧水。分别用ICP―MS法及ADD―ICPMS法测量了注入的臭氧水及晶圆表面的金属杂质浓度。
臭氧是仅次于氟的强氧化剂,是利用该氧化力,除去附着在晶圆表面的有机物及金属杂质的方法。以前,除去有机物用SC-1洗净或者硫酸和过氧化氢的混合溶液除去,金属杂质用SC-2洗净除去。作为除去有机物及金属杂质的方法,使用添加臭氧的超纯水。以超纯水为原料,通过电解方式产生的清洁臭氧气体,通过透过膜组件溶解在超纯水中。 添加臭氧的超纯水基本处于中性区域,具有较高的氧化还原电位,因此可以从金属及有机物中夺取电子进行氧化。
通过电解含有离子的超纯水,可以通过电泳在阳极侧生成酸性电解水和在阴极侧生成碱性电解水。通过向超纯水中添加符合目的的电解质进行电解,可以调整离子水的氧化还原电位及pH特性。添加了电解质的电解阴极水具有去除Cu及Fe的效果,可以考虑代替酸性溶液。电解阳极水具有除去二氧化硅粒子的效果,是与SC―1洗净相同的洗净方法。
总结
本文报告了硅片清洗的概论、最近的新清洗法及相关技术的评论。为了应对器件的高集成化及高性能化,晶圆表面的高品质化非常重要,而且大口径化成为导火索,不仅需要传统的清洗技术,还需要突破。洗净作为生产技术,不仅要根据经验·诀窍进行开发,还需要从理论分析出发考虑洗净技术。另外,表面的高品质化不仅仅是清洗,洁净室的维持管理晶片的包装及保管方法也很重要。