
扫码添加微信,获取更多半导体相关资料
关于氮化硅和二氧化硅层上的金属去除,先前的研究表明,通过蚀刻几埃的受污染材料可以实现非常有效的清洗,通过为多晶硅蚀刻和晶圆变薄而开发的湿蚀刻化学方法,可以获得最高的硅蚀刻速率(每分钟几微米),这些化学物质通常是HF/HNO3混合物、FNPS(HF/HNO3/H3po4/h2so4)或商业解决方案,如默克纺丝机®系列,然而,由于蚀刻的硅的厚度和均匀性难以控制,这些化学方法不适合重复清洗步骤。
此外,二氧化硅和氮化硅的蚀刻速率降低了10到100倍,所以无论基质如何,都不能使用相同的配方,研究发现,直高频清洗对二氧化硅和氮化硅的铜去污非常有效,在工业环境中,通过仅蚀刻7A的氮化硅,铜污染可从1012at/cm²降低到1010at/cm²,虽然这种清洗方案目前用于集成电路制造厂,但它不能解决硅表面的金属去污,特别是过渡金属,因为它不蚀刻硅或具有较低的氧化还原电位值,如果可以通过调整稀释度和化学比来控制Si和二氧化硅上的蚀刻速率,则不会蚀刻氮化硅。
在这项研究中,我们研究了一种解决方案,使我们能够通过改变混合物成分和温度来“调整”和控制硅、氮化硅和氧化硅的蚀刻速率,我们选择了一种h2o:h2o2:h2so4:HF(dHF-SPM)混合物,因为它可以独立地控制3种感兴趣材料的蚀刻速率,而不会粗糙硅表面,含dHF-SPM混合物的硅蚀刻是基于h2o2:h2so4混合物同时氧化硅和随后的dHF氧化硅蚀刻,在给定的温度下,通过结合使用酸性新鲜化学和单晶圆工具,可以实现较高的清洁效率,因为金属种类既可以溶解在酸性介质中,也可以被化学流提升和清除。
根据SEZ的经验,设置了化学流量、晶圆自旋速度、化学分配器臂“吊臂摆动”、冲洗和干燥条件等参数,以实现良好的均匀性和较短的工艺时间,所有试验均使用新鲜(非再循环)化学物质,我们根据LETI的内部规范考虑了关键的背面金属水平,即生产批次的5E11at/cm²,监测晶片的1.5E11at/cm²。
由于之前的研究表明,几埃的蚀刻就足以显著降低铜的污染,我们的目标是获得约10a/分钟的蚀刻率,对硅和氮化硅,且小于50a/分钟,在热氧化物上,对于dHF-SPM混合物中的硅蚀刻,硅表面氧化作为速率限制步骤;因此,HF浓度不应影响硅蚀刻速率,对于二氧化硅和氮化硅底物,蚀刻速率主要取决于高频浓度和温度。
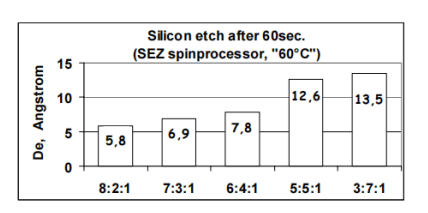
图1
通过改变混合物中的过氧化氢和硫酸比值来关注硅的蚀刻率,温度设置为60°C,以激活Si表面氧化反应,高频浓度为0.5%,随着过氧化氢含量的增加,硅蚀刻从5.8A增加到13.5A/min(图1),但体积比为5:5:1的混合物似乎达到了一个平台期,选择这种组合物进行最后的清洁测试,在第二步中,我们调整了高频浓度,以达到在氮化硅和氧化硅上所需的蚀刻速率,在60°C下,HF浓度为0.1%~0.5%,氮化硅的蚀刻速率为5~25A/min,二氧化硅值从10到140A/分钟,对于硅蚀刻速率最低的混合物(比率8:2:1,图2),充分验证了硅蚀刻速率与高频浓度的独立性。
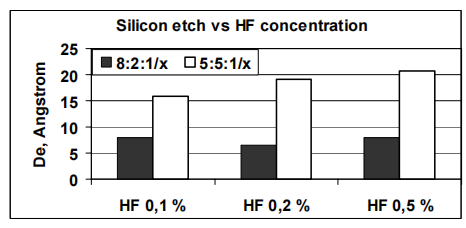
图2
我们注意到,在过氧化氢含量较高的化学混合物中(比值为5:5:1)时,蚀刻速率略有下降,正如我们预计硅氧化速率会随着氧化剂浓度和非常低的高频浓度的增加而增加,限制步骤可能是氧化硅蚀刻速率。最后,选择0.2%的HF浓度,以避免限制硅蚀刻,因为在氮化硅和热二氧化硅(60°C)上分别获得了合适的蚀刻速率,分别为10A/min和35A/min,经过5次清洗后,AFM对硅片的粗糙度没有显著增加。
我们开发的清洁溶液对过渡金属和其他类型的污染表现出良好的性能,通过在硅晶片上的故意污染,初始金属水平接近1E13at/cm²是通过故意污染获得的,然后,通过在退火晶片上用5:5:1/0.2混合物(60°C60秒)蚀刻10A硅,达到1E10at/cm²下的残留污染水平。
然后,我们重点研究了四个可能会增加一些外来污染的新兴过程:HfOSix和Y2O3高k材料的沉积;ITO的沉积,可作为上述IC元件中的透明电极;以及用于MRAM应用的铁磁层的沉积。我们观察到初始污染水平(未在同一运行中沉积)的晶圆间的显著变化,从E10到E13at/cm²。清洗后,最终达到5E10at/cm²以下的污染水平。
在一个封闭的腔室中,来自被污染气体流动的颗粒(在晶片表面均匀分布),从而获得了非常高的初始污染水平,1min可接受70~95%,清洁然而,从工具操作和卡盘接触中去除颗粒要困难得多,在这个测试中,初始粒子数要低得多,但PRE几乎可以忽略不计(0到20%)。虽然来自野鸭的颗粒污染很高,并且在每个积分步骤中都有增加的趋势,但与焦点的相关性没有得到证明,结果表明,聚焦点与处理系统造成的非常大的背面缺陷,或卡在光刻工具卡盘上的大粒子更好地相关,而不是晶圆背面粒子数。
由于单晶片序列的工艺时间短,金属去除仍然具有挑战性,在SEZ自旋处理器上研究了背面清洗,该处理器具有一种易于使用的化学方法,专门用来通过使用相同的配方去除硅、氧化硅或氮化硅背面涂层上的金属污染,我们重点研究了过渡金属和“外来”污染物,并表明无论使用何种衬底,都可以获得良好的金属去除效率。