
扫码添加微信,获取更多半导体相关资料
本文描述了一种新的和简单的方法,通过监测腐蚀过程中薄膜的电阻来研究湿法腐蚀ITO薄膜的动力学,该方法能够研究0.1至150纳米/分钟之间的蚀刻速率。通常可以区分三种不同的状态:(1)缓慢的初始蚀刻;(2)快速整体蚀刻阶段和(3)结束时的缓慢蚀刻阶段。表明方法特别适合于研究蚀刻过程结束时的现象,在这种情况下,孤立的膜块仍然粘附在衬底上。
由于其相当高的导电性和光学透明度,氧化铟锡(ITO)是用于显示器、触摸面板、太阳能电池和其他相关应用的最广泛使用的透明导电氧化物(TCO)之一,ITO薄膜的图案化通常通过光刻来完成,光刻包括在工业过程中主要是湿法蚀刻的蚀刻步骤。
在ITO的湿法蚀刻研究中,通常没有明确提到评估蚀刻速率的程序,由于这些研究的焦点是总的蚀刻速率,所以蚀刻速率可能是通过将膜厚度除以总蚀刻时间来评估的,然而,没有提到如何确定总蚀刻时间,评估蚀刻速率的基本假设是蚀刻速率在蚀刻过程中是恒定的。
在蚀刻ITO和其它透明导电材料如SnO2和ZnO的薄膜期间,对蚀刻速率的研究需要监测薄膜的厚度或质量相关量,光学监测方法可以是椭偏测量、直接透射和反射测量或通过光栅结构测量透射和反射,因为对于非常薄的膜(< 50nm),透射和/或反射的直接测量不足以评估厚度,在ITO膜中制备光栅结构需要避免蚀刻不足的蚀刻技术,由于这在部分无定形的ITO膜中不总是可能的,并没有考虑应用这种技术。
此外,测量非常薄的ITO膜的厚度是麻烦的,因为表面粗糙并且在衬底表面上形成孤立的ITO残留物,为了监测蚀刻过程中的蚀刻速率,应用了电阻相关的测量技术,该技术不需要光刻技术来制备样品,并且可能存在上述问题,此外,导电性是诸如ITO的透明氧化物膜的最重要的性质之一,电阻是一个便于测量的参数,它与通过蚀刻工艺获得的器件的电特性直接相关,新方法并不局限于ITO,还可用于研究各种导电膜的腐蚀动力学。
在描述了蚀刻过程中电阻监测方法的基本要素之后,讨论了电阻监测曲线的形状,并表明从这些曲线中可以获得与ITO更相关的蚀刻速率。设计了一种在酸性蚀刻剂如盐酸(HCl)和草酸(H2C2O4)中蚀刻ITO薄膜期间监测电阻的方法,这种监测以如下方式进行:每分钟从蚀刻溶液中取出样品,并测量溶液外的电阻,特意选择了这种方式,因为当膜在蚀刻溶液中时,原位测量电阻会受到导电蚀刻溶液中寄生电流的影响,在测量之前,样品在超声浴中在50C的蒸馏水中清洗1分钟,用蒸馏水和酒精冲洗,并在100℃下干燥,该程序将最小蚀刻时间限制为1分钟,而从溶液中取出样品并在蒸馏水中洗涤以停止反应所需的时间通常为7秒,这不会显著增加测定蚀刻时间的误差,没有使用碱来停止反应,确保在测量过程中没有额外的试剂被吸附在ITO表面上。
我们通过间隔10 毫米的平行触点测量样品的电阻,这产生了平行的2个方块,因此薄层电阻是测量电阻的两倍。为了保证稳定和低接触电阻,制造了一种特殊结构的夹具,它是由一根长度可调的绳子拉动的悬臂制成的,可以向一个工具施加高达4公斤的力,该工具将样品压向两根由镀锡铜编织线制成的导体,这些线通过PVC隔板在100米内平行(平行度偏差< 1%),薄ITO膜的薄层电阻足够高,使得也能够使用4点测量,在这种情况下,使用Jandel HM21 4点探针头测量电阻,该探针头配备有间隔1毫米的碳化钨针,通过在样品上施加和释放压力来模拟实验条件,对同一样品进行一系列20次测量,测试2条测量的可重复性,电阻测量的平均偏差优于0.5%,该夹具允许在蚀刻过程中快速测量电阻。
在草酸和盐酸中腐蚀了25和175纳米两种不同厚度的ITO薄膜,在蚀刻过程中,25纳米ITO膜的电阻从初始值98/增加到无穷大,下图示出了蚀刻过程中电阻的归一化倒数值的变化。图中的纵轴表示R0/R,其中R0是蚀刻前的初始薄层电阻,R是实际薄层电阻,在蚀刻过程中按照上一节所述的方法测量。图中显示ITO薄膜的严格脱脂会影响初始蚀刻行为。
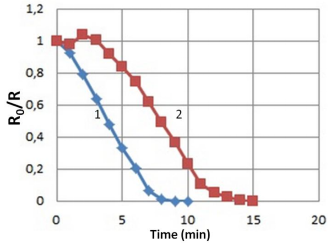
总蚀刻时间tetch是从反应开始到电阻比未蚀刻膜的电阻大至少10倍的点所测量的时间。当测得的样品电阻超过200 M时,停止蚀刻,由于这一标准不能确保所有材料都已从玻璃表面去除,因此应特别注意蚀刻过程的最后阶段。

图中的曲线示出了在总蚀刻时间tetch期间蚀刻过程的3个阶段:由t0(开始时间)表示的缓慢蚀刻的初始蚀刻周期,在tb(整体蚀刻时间)期间R0/R相当快速的降低,以及在结束tr(剩余蚀刻时间)的缓慢蚀刻, 开始时间t0定义为线性行为开始的时间,tr定义为从该线性部分结束直到R0/R小于10-7所经过的时间。可以通过绘制R0/Rt的一阶和二阶时间数值导数来确定状态之间的转换。
考虑蚀刻速率de/dt(单位为纳米/分钟),其中e表示溶液中均匀各向同性膜的厚度,该溶液被充分搅拌,并且与ITO分子相比还具有大量过量的蚀刻剂分子,如果没有反应物的自催化作用,那么de/dt是常数:换句话说,e随时间线性减小,膜的初始厚度由e0表示,在蚀刻液中一段时间后,我们得到et。在等式(1a)和(1b)中,导电薄膜的电阻率被认为与厚度无关。这在薄膜中通常是不正确的,因为在小的薄膜厚度下,由于电子自由程大于薄膜厚度的事实,观察到在薄膜表面的电子散射效应增加。这导致与体电阻率的偏差,并且在> ~300nm的薄膜中观察到较大的电阻率,观察到的薄膜厚度较小时电阻率的增加,通过蒸发沉积的ITO膜的电阻率在100纳米以下增加了2倍,因为当蚀刻后薄膜变得越来越薄时,微晶形态和微晶间电连接的不均匀性可能会起更大的作用。
在蚀刻过程结束时,观察到玻璃上孤立的ITO岛,只要ITO微晶彼此接触,电阻就具有有限的值,在孤立的ITO微晶的情况下,假设电阻将是无穷大,在均匀岛的情况下,这种转变预计是急剧的:类似于从渗透到非渗透的转变,在大多数情况下,没有观察到从有限电阻到无限电阻(> 10M)的急剧转变,因此,一个简单的基于渗流的模型不能解释我们的结果,对我们的结果的一个可能的解释是,在孤立的ITO岛之间的玻璃表面上有离子传导。这可能是由于在沉积后的后退火期间Na扩散到ITO膜中而形成NaInxOy化合物造成的。 提出了一种通过监测电阻来研究导电薄膜湿法腐蚀动力学的新方法。该方法已经对25和175nm的ITO薄膜进行了测试,这种新方法能洞察蚀刻过程,通常可以区分三个不同的阶段:具有非常慢的蚀刻速率的初始阶段、对于膜的大部分的快速蚀刻速率以及在最后的缓慢蚀刻速率。基于记录总蚀刻时间的蚀刻速率通常会低估相关的蚀刻速率:建议从R0/R曲线中的时间线性阶段计算蚀刻速率。此外,还认为这个方法特别适合于研究蚀刻过程结束时的现象。